三星率先开发出12层3D-TSV芯片封装技术
2019-10-09
 {{format_view(7946)}}
{{format_view(7946)}}
相关舆情
AI解读
生成海报
(文/Oliver),三星电子在10月7日宣布,已率先在业内开发出12层3D-TSV(硅穿孔)技术。该技术在保持芯片尺寸的同时增加了内存容量。
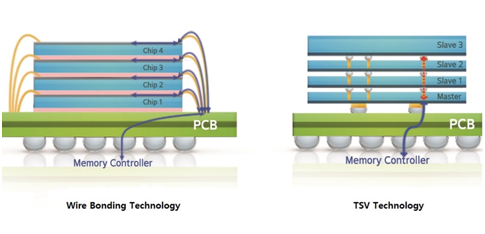
据介绍,该技术垂直堆叠了12个DRAM芯片,它们通过60000个TSV孔互连,每一层的厚度仅有头发丝的1/20。三星表示,这是目前最精确和最具挑战性的半导体封装技术。
三星补充道:“利用这项新技术,可以堆叠12个DRAM芯片,同时保持与现有8层HBM2产品相同的封装厚度,即720μm。这对客户来说意味着即使系统设计没有任何变化,也可以生成高容量和高性能的产品。”
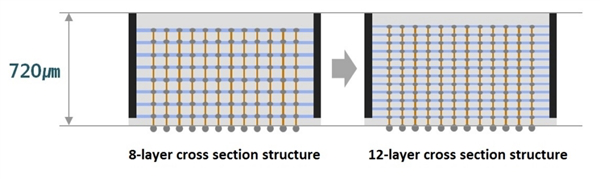
三星还透露,基于12层3D TSV技术的HBM存储芯片将很快量产,单片容量从目前的8GB来到24GB。
“最新的封装技术在AI、自动驾驶和HPC(高性能计算)等领域变得越来越重要,”三星电子DS部门副总裁Baek Hong-joo说道。“我们将通过12层3D-TSV技术在半导体封装领域保持领先地位。”
(校对/holly)

责编:
刘燚
*此内容为集微网原创,著作权归集微网所有,爱集微,爱原创
三星

晶圆产能释放利好,溅射靶材三厂竞速


 专利申请
专利申请
 知识产权质押融资
知识产权质押融资
 专利地图分析
专利地图分析
 版权登记
版权登记
 集成电路布图设计
集成电路布图设计
 商标交易
商标交易
 商标申请
商标申请
 专利交易
专利交易
 专利无效
专利无效



热门评论