开启后摩尔时代,先进封装大有可为

自1965年摩尔定律被提出后,半导体行业便一直遵循其轨迹高速发展。然而近年来随着物联网、大数据、5G通讯、AI与智能制造等技术的不断突破创新,业内对于外型更轻薄、数据传输速率更快、功率损耗更小,以及成本更低的芯片需求大幅提高。这使得单纯依靠精进制程来提升芯片性能的方法已无法满足时代的需求,摩尔定律面临着难以突破的瓶颈,于是先进封装技术变得越来越重要。
先进封装:后摩尔时代的主要驱动力
封装技术是芯片和PCB之间的桥梁。在后摩尔时代,随着制程的不断推进,封装正在向更高密度和更高集成的方向发展。在这个过程中,如WLCSP(FI WLP)、FO WLP、2.5D、3D等晶圆级先进封装技术扮演着重要角色。
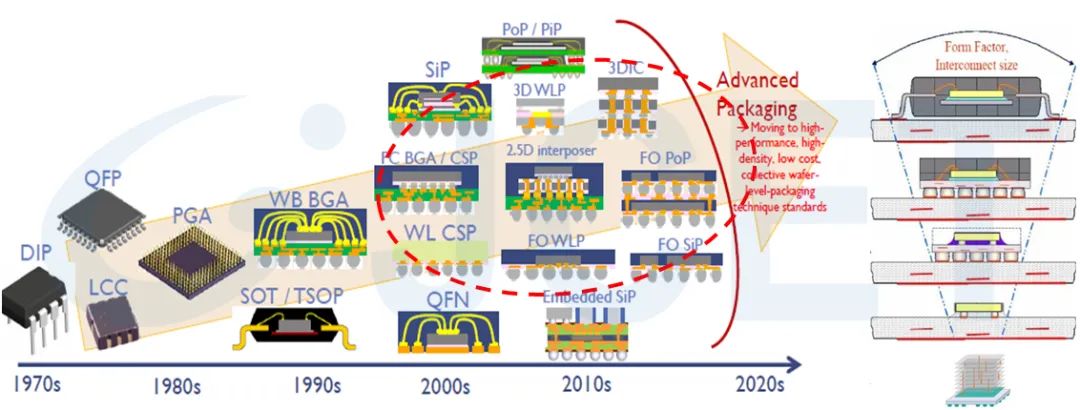
(Source:Yole Development)
目前,FO WLP主要用于通信、消费、汽车、高性能计算和工业领域。相比于其它封装技术,FO WLP技术的关键特性在于,线路及管脚超出芯片范围、使用塑封料包覆芯片以及利用RDL(重布线层)进行连接等。因此,该技术且具有非常广泛的市场前景。
据相关预测,如按封装体计算,2020-2024年扇出型封装出货量将以15.5%的年复合增长率增长,到2024年出货量将达到344亿个;如按晶圆计算,同一时期年复合增长率达29.7%,2024年将达到383万片。

(©2020 TechSearch International. Inc.)
长电科技XDFOI™多维先进封装技术为高密度异构集成提供全系列解决方案
应市场发展之需,长电科技推出了XDFOI™多维先进封装技术,该技术是一种面向Chiplet(小芯片)的极高密度、多扇出型封装高密度异构集成解决方案,其利用协同设计理念实现了芯片成品集成与测试一体化,涵盖2D、2.5D、3D集成技术,能够为客户提供从常规密度到极高密度,从极小尺寸到极大尺寸的一站式服务。
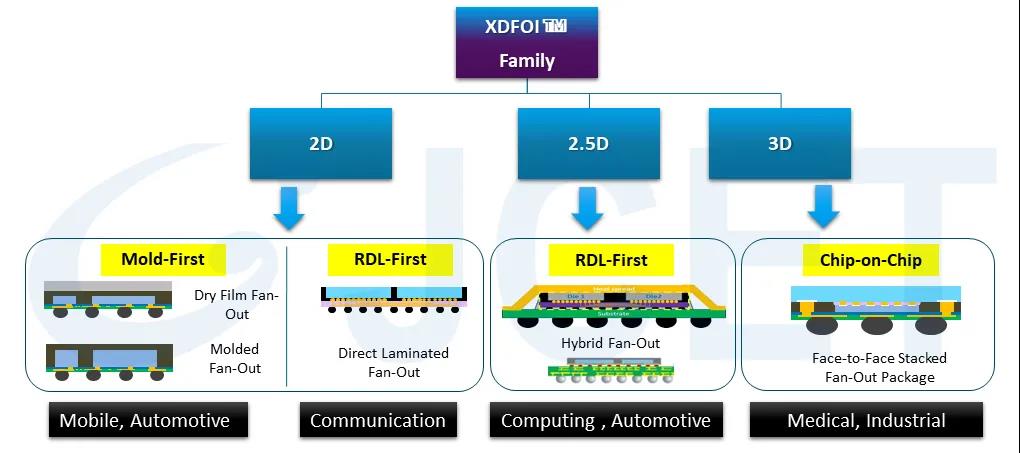
XDFOI™-2.5D技术优势:
XDFOI™-2.5D是一种新型TSV-less超高密度晶圆级封装技术,因此,其在系统成本、封装尺寸上都具有一定优势。在设计上,该技术可实现3-4层高密度的走线,其线宽/线距最小可达2μm。此外,XDFOI技术所运用的极窄节距凸块互联技术,还能够实现40x40mm的封装尺寸,并支持在其内部集成多颗芯片、高带宽内存和无源器件。这些优势可为芯片异构集成提供高性价比、高集成度、高密度互联和高可靠性的解决方案。

XDFOI™-2.5D的应用:
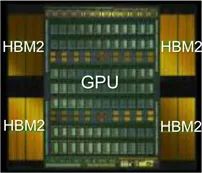
(Source:NVIDIA.)
XDFOI™通过将不同功能的器件整合在系统封装内,可达到大幅降低系统成本的同时缩小封装尺寸。其应用场景主要集中在为对集成度和算力有较高要求的FPGA、CPU、GPU、AI和5G网络芯片等应用,提供小芯片和异构封装(HiP)的系统封装解决方案。
目前,长电科技DSC(设计中心)已具备电气、机械、热仿真和协同设计的能力,可实现XDFOI封装设计和仿真。

如今,扇出型封装正朝着具有更精细布线层的复杂结构发展。它们需要具备更高的RDL密度、更多的RDL层数、更小的凸块间距、更大的扇出尺寸以及更先进的架构。
在这个趋势下,各大厂商如何检验并提高良品控制率、提升产品的性能与可靠性以及平衡成本与质量之间的问题仍然是巨大的挑战。对此,长电科技作为业界领先的芯片成品制造商,定当不断精进自己的技术和服务能力,推出兼具高性价比、高集成度、高密度互联和高可靠性的解决方案,助力先进封装创新迈向新高度。


“群舟结阵来,AI舞芯潮”,2026半导体投资年会在沪圆满举行


 专利申请
专利申请
 知识产权质押融资
知识产权质押融资
 专利地图分析
专利地图分析
 版权登记
版权登记
 集成电路布图设计
集成电路布图设计
 商标交易
商标交易
 商标申请
商标申请
 专利交易
专利交易
 专利无效
专利无效



热门评论