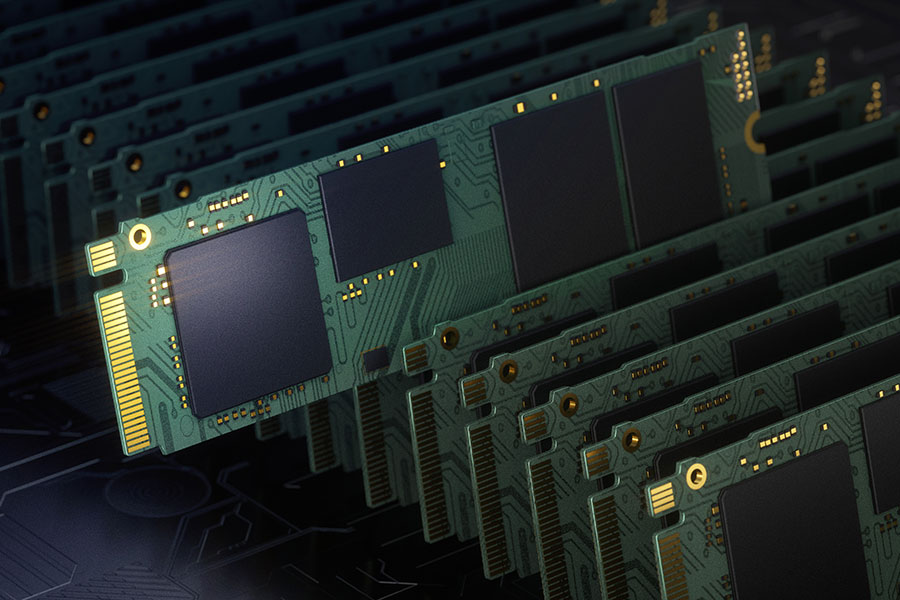
集微网消息,三星电子表示,已经研发制造出16层堆叠的高带宽存储(HBM)的样品。
三星副总裁Kim Dae-woo表示,三星采用混合键合技术制造了该芯片。他表示,虽然16层堆栈HBM距离投入量产还需要一段时间,但证实其运行正常。
Kim Dae-woo还补充说,该芯片是作为HBM3制造的,但三星计划在HBM4中使用来提高生产率。
消息人士称,由于对准问题,三星预计只会对一两个芯片堆叠组使用混合键合,但后来将该技术应用于所有堆叠。该样品是使用三星晶圆厂设备子公司Semes的设备制造的。
Kim Dae-woo还表示,三星正在考虑在HBM4中使用混合键合或热压非导电薄膜(TC-NCF),并将于2025年推出样品,2026年开始量产。新推出的HBM3E使用TC-NCF技术。
混合键合更具优势,因为它们可以紧凑地添加更多堆叠,而无需使用填充凸块进行连接的硅通孔(TSV)。HBM上的核心芯片DRAM也可以通过相同的技术变得更厚。
国际半导体标准组织(JEDEC)同意将HBM4的封装厚度定为775微米(比上一代厚55微米),因此HBM4外形尺寸可能还不需要混合键合,仍可使用现有的键合技术实现16层DRAM堆叠HBM4。
Kim Dae-woo还表示,在最多8层堆叠的情况下,大规模回流模制底部填充(MR-MUF)的生产效率比TC-NCF更高,但一旦堆叠达到12层或以上,后者将具有更多优势。
Kim Dae-woo还指出,当HBM4推出时,定制需求预计会增加。他补充说,缓存芯片将变更为逻辑芯片,因此芯片可以来自三星电子或台积电。
(校对/刘昕炜)


 登录
登录