1.敏芯微“微差压芯片的制造方法与微差压芯片”专利获授权
2.展讯通信“芯片封装及其制作方法、电路板”专利公布
3.长电科技“封装结构以及封装方法”专利公布
4.芯联集成“红外传感器及其制备方法”专利公布
1.敏芯微“微差压芯片的制造方法与微差压芯片”专利获授权
天眼查显示,苏州敏芯微电子技术股份有限公司近日取得一项名为“微差压芯片的制造方法与微差压芯片”的专利,授权公告号为CN118359167B,授权公告日为2024年10月18日,申请日为2024年6月19日。

本发明的实施例公开了一种微差压芯片及其制造方法,其中的制造方法包括:提供衬底,在衬底的一侧形成振膜层;在振膜层背离衬底的一侧形成牺牲层;对牺牲层进行刻蚀以形成第一通孔;在牺牲层背离衬底的一侧形成第二介质层和导电层,在第一通孔内填充形成第一支撑结构;对导电层和第二介质层进行刻蚀以形成释放孔以及均压通道;释放牺牲层,以形成间隙层;形成绝缘层,绝缘层密封释放孔;在均压通道内对振膜层进行刻蚀,以形成与均压通道连通的均压孔;在衬底背离振膜层的一侧对衬底进行刻蚀,以形成背腔,背腔通过均压孔与均压通道连通,以得到微压差芯片。本发明避免了污染颗粒能在芯片内直接通过均压通道进入间隙层,提高产品的可靠性。
2.展讯通信“芯片封装及其制作方法、电路板”专利公布
天眼查显示,展讯通信(上海)有限公司“芯片封装及其制作方法、电路板”专利公布,申请公布日为2024年10月18日,申请公布号为CN118800739A。

本申请涉及一种芯片封装及其制作方法、电路板,芯片封装包括基板、封装件和至少一个晶粒,基板具有一个安装面,至少一个晶粒固定于安装面,封装件包括侧壁和盖板,侧壁固定于安装面,并间隔环绕于至少一个晶粒的外围,盖板与侧壁固定连接并位于至少一个晶粒背离安装面一侧,盖板朝向安装面的内表面包括至少一个导热凸起,沿安装面的平面方向每个导热凸起用于对齐一个晶粒,沿基板的厚度方向每个导热凸起用于抵接一个晶粒。本申请芯片封装的封装件能够改善芯片封装整体的翘曲,且盖板的导热凸起的导热效果较好,晶粒工作过程中发出的热量可以通过导热凸起传导至外界以获得较好的散热效果,进而提高芯片封装的可靠性并延长其使用寿命。
3.长电科技“封装结构以及封装方法”专利公布
天眼查显示,江苏长电科技股份有限公司“封装结构以及封装方法”专利公布,申请公布日为2024年10月18日,申请公布号为CN118800765A。

一种封装结构以及封装方法,封装结构包括:引线框架,引线框架包括第一面,引线框架包括基座和位于其两侧的第一管脚;第一芯片,设置于基座的第一面上;第一导电线,位于引线框架的第一面上且横跨第一芯片,第一导电线的两端分别与第一管脚电连接。多根第一导电线近似形成了一个连续的导电表面,该连续的导电表面具有能够阻挡电磁波穿透的作用,降低了第一芯片受到电磁干扰的概率,同时,在后续形成塑封层之后,塑封层能够覆盖多根第一导电线,使多根第一导电线位于塑封层中,多根第一导电线在起到电磁屏蔽效果的同时,还能降低封装结构的厚度,有利于封装结构的体积小型化,从而提高了封装结构的性能。
4.芯联集成“红外传感器及其制备方法”专利公布
天眼查显示,芯联集成电路制造股份有限公司“红外传感器及其制备方法”专利公布,申请公布日为2024年10月18日,申请公布号为CN118794543A。
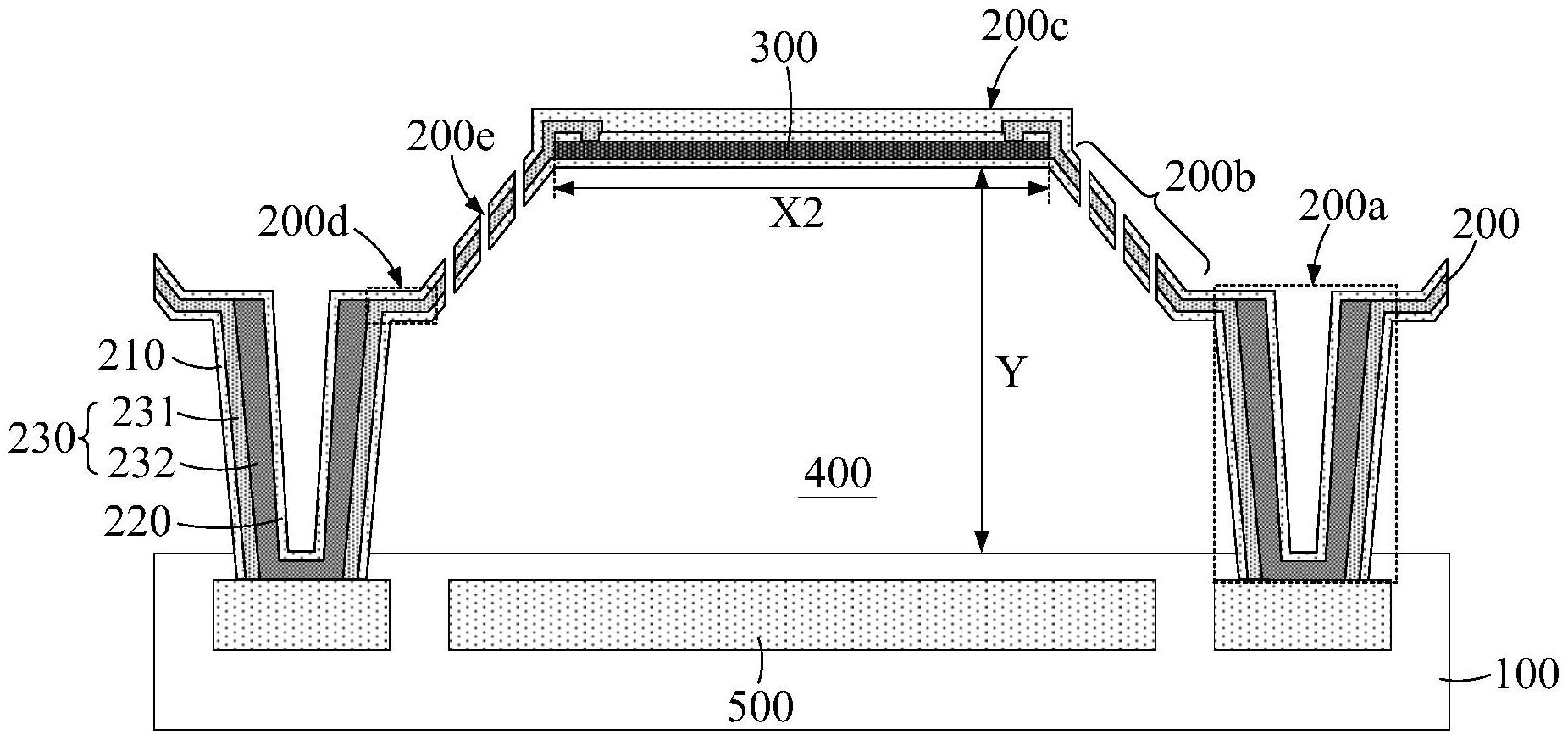
本发明提供了一种红外传感器及其制备方法。通过对微桥结构进行优化,使微桥结构具有桥墩、桥腿和桥面,并且桥腿相对于桥面倾斜而倾斜连接在桥面和桥墩之间,由于桥腿呈倾斜设置,从而可以在同一投影面积下增加桥腿的实际长度。以及,通过设置倾斜的桥腿,即可释放出更大尺寸的桥面用于配置敏感元件,增加了敏感元件在器件单元内的占比,进而可有效提高器件响应率等性能。