
降低GaN材料缺陷密度、提高晶体材料质量是当前第三代半导体领域最具挑战的课题之一,而在廉价且配套产业完善的硅衬底上实现高质量GaN材料的外延生长则是产业发展的最重要战略方向和迫切需要。
北京大学物理学院、人工微结构与介观物理国家重点实验室胡晓东教授与美国加州大学洛杉矶分校谢亚宏教授、日本名古屋大学天野浩教授(2014年度诺贝尔物理学奖获得者)合作,利用独特的外延生长技术,制备了具有三维蛇形通道的立体叠层掩膜衬底,并在硅晶圆上异质外延生长高质量GaN晶体,制备了GaN基肖特基二极管(SBD)和PN结二极管(PND),展现出优异的物理性能。
北京大学消息显示,该项研究工作是国际上首次实现异质衬底侧向外延制备横向结构的GaN基功率电子器件,展示了以极低廉的衬底成本实现高性能器件的可行性;为解决当前高性能GaN基功率电子器件所面临的一些瓶颈问题提出极具成本优势的全新方案,展示了广阔的产业应用前景。
在SBD上,理想因子n下探至罕见的1.0,并在7个数量级的电流范围内保持在1.05以下;其开启电压低至0.59 V,电流开关比高达1010,软击穿电压达175 V@0.05 A/cm2;在PND上,理想因子n下探至1.8,优于大多数GaN基PND,其室温击穿电压达到490 V,在单边结模型下(非穿通)导出临界电场强度高达3.3 MV/cm,与理论极限值一致,刷新了异质外延GaN基器件耐压的世界纪录,实际上也高于其他报道的同质外延GaN基器件的耐压。
有别于传统侧向外延,立体叠层掩膜衬底上外延的GaN晶体实现了在完整的条形区域内都是低位错密度的高质量区,为更复杂的高性能跨窗口区的功率电子器件提供了无限可能。
此外,受益于横向的生长调控实现了各层的堆叠方向是非极性的(110)晶面,从而避免极化电场对能带结构的影响,有望应用于对极化场散射敏感和对频率性能要求高的电子器件;其横向设计也使得漂移层宽度可轻松做到超越大电压下的耗尽区宽度,而不受异质外延垂直结构中晶体厚度与晶体质量之间矛盾的制约。
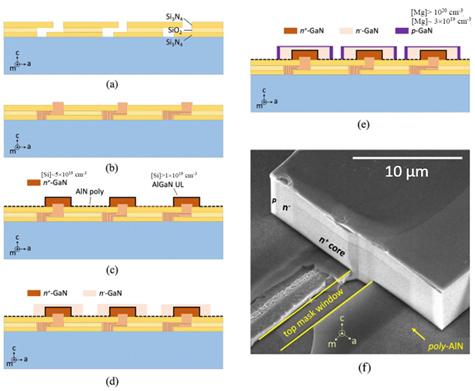
图片来源:北京大学
据悉,相关研究成果以“异质衬底上的GaN基非极性横向功率二极管”为题,5月24日在线发表于《应用物理快报》。同时,上述工作还得到国家自然科学基金、国家重点研发计划等支持。(校对/若冰)







