
图源:网络
在14日举行的ICEPT 2021电子封装技术国际会议上,中国科学院深圳理工大学先进材料科学与工程研究所副所长张国平发表主题演讲表示,先进封装已成为超越摩尔定律的关键赛道,但国产化仍然任重道远。

张国平称,随着台积电、英特尔、三星电子等前道晶圆厂的加入,先进封装正在受到业内瞩目。从传统封装到先进封装,对性能的追求是小型化、轻薄化、更高性能、更低功耗以及更低成本等等,其中封装材料的重要性不言而喻。
但在先进封装材料领域,目前全球的主要玩家仍然是日本、欧美等国的厂商,中国由于起步较晚,基础比较薄弱,当前尚未出现有竞争力的玩家。
具体到几大关键材料,ABF由日本味之素完全垄断,TIM1(热界面材料)、PSPI(光敏聚酰亚胺)市场同样由日本主导,Underfill(底部填充胶)方面,市场则由日本、欧美等发达国家瓜分,而TBDB材料由美国厂商主导,也是当前国产化突破领域。
据张国平介绍,由中国科学院深圳先进技术研究院研发的TBDB材料目前全球市占率已达到7%,是美国3M公司、布鲁尔以及日本的TOK后,第四大供应商。
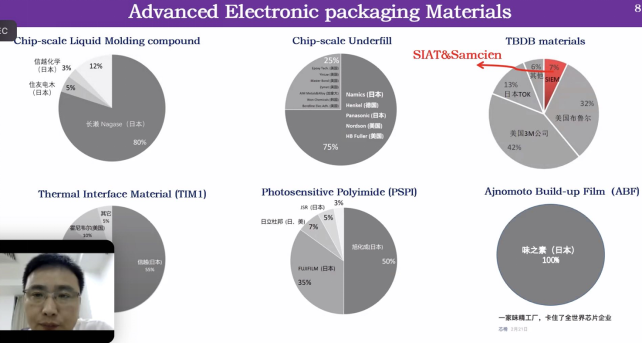
张国平表示,部分核心技术的突破给与了国产化信心,但整体而言与国际巨头的距离以及国产化缺口还很大,仍需要集合国内人才和技术研发人员继续努力和发展。
(校对/小山)









