
3月15-16日,第十九届中国半导体封装测试技术与市场年会(CSPT 2021)正式召开。本次会议以“创新引领、协作共赢、共建芯片成品制造产业链”为主题,对芯片成品制造的创新与趋势、封装测试与设备、关键材料等行业热点问题进行研讨。
在首日举行的高峰论坛上,通富微电子股份有限公司技术行销副总王鹏发表了题为《后摩尔时代封装创新趋势分析》的演讲中,其表示,基于硅桥(Si Bridge)的2.X D技术将会是封装企业的主流发展方向。
近年来,CPU和GPU的裸片尺寸越来越大,随之而来的是晶圆制造的良率和效率的降低,在晶体管成本进一步上升的前提下,其微缩速度也逐渐下降。由此,摩尔定律走向终结的论调甚嚣尘上,超越摩尔成为业内的一种主流声音,而先进封装成为了其中关键所在。
据王鹏介绍,目前大批量主流生产的先进封装包括FCMCM(Flip Chip Multi Chip Modules,覆晶多芯片组件)、FOMCM(Fan-Out Multi Chip Modules,扇出型多芯片组件)、EMIB(Embedded Multi-die Interconnect Bridge,嵌入式多芯片互联桥接)以及基于硅中介层的传统2.5D封装。
而在更高端的小批量生产的技术领域,3D封装在传统2.5D封装的基础上增加了垂直面的封装,目前被应用于最尖端的产品。另外,还有一种基于硅桥的2.X D封装,与3D封装通过TSV实现垂直互联不同,2.X D封装将不同裸片通过基板上的硅桥连接在一起,虽然密度可能低于3D封装,但具有成本优势。
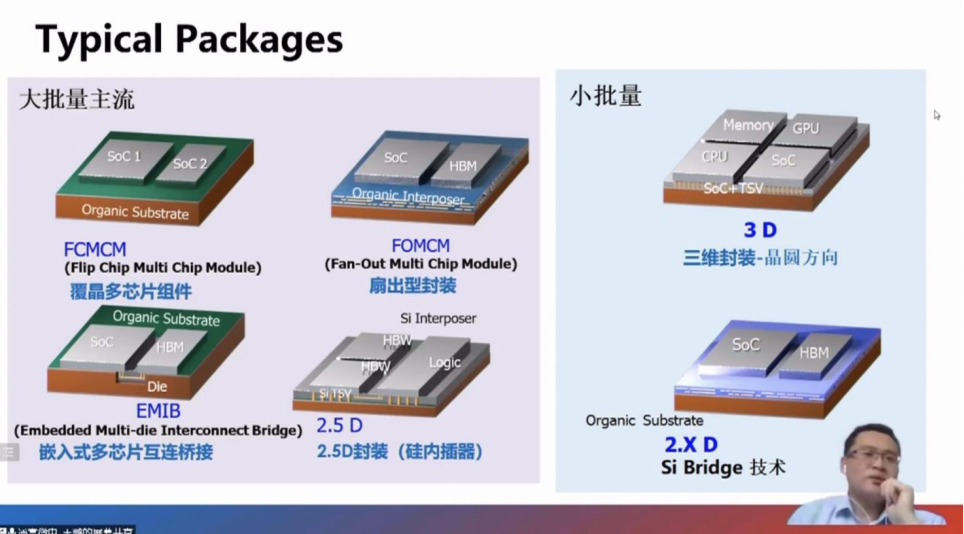
王鹏表示,虽然目前在涨价潮下,下游厂商对价格的忍耐度较高,但从长期驱动力来看,2.X D封装将会是市场上具有强竞争力的封装产品。而对于封装厂来说,2.X D封装最大的不同在于对硅的依赖度低,在此基础上就可做基础的深度开发工作,与客户产品做高度绑定,因此将会是一个主流的发展方向。
据其介绍,在后摩尔时代,通富微电提出了名为ViSionS的total solution,融合先进封装技术,围绕HPC、存储器、SiP三个方向进行布局。其中2.5D技术已于2021年成功开发,实现样品制作,目前正在配合客户做进一步产品认证和量产规划,预计2022年下半年到2023年,一些客户会逐渐进入2.5D封装量产阶段。(校对/隐德莱希)









