过去的半个多世纪,半导体行业一直遵循摩尔定律的轨迹高速发展,如今单纯靠提升工艺来提升芯片性能已经无法充分满足发展的需求,半导体行业也逐步进入了“后摩尔时代”。
后摩尔时代的来临,给中国集成电路产业发展带来新的发展机会,长电科技作为全球领先的集成电路制造和技术服务提供商,提出从“封测”到“芯片成品制造”的概念升级,带动行业重新定义封装测试的产业链价值。

市场、技术和经济驱动力

全球的半导体市场规模飞速增长,然而成本也随之“水涨船高”。从晶体管层面来看,市场投资先进制程,通过晶体管缩放提高晶体管数量来获得更好的性能和控制成本。在系统层面,通过不断增加功能模块的系统集成来获得更高的性价比。先进制程主要是智能手机的需求,成本高,主要是为了降低功耗、减小尺寸。但是这部分需求仅占到了市场需求的三分之一左右,这使得更大规模的市场寻求以更低成本的解决方案来实现更优化的性能。这就使得异构集成的先进封装越来越受重视。
异构集成需要真正的协同设计合作
“事实证明,用单独封装和互连的较小功能构建大型系统可能更具经济效益。大型功能的可用性,结合功能设计和构建,应该允许大型系统的制造商快速且经济地设计和构建相当多的设备。”引述自戈登摩尔的观点。IEEE HIR公布的半导体技术路线图中也表示,为了应对不断扩大的市场并实现持续进步,路线图更侧重于系统级集成和先进封装技术,就像过去50年通过遵循摩尔定律和ITRS推动的发展那样。
多尺度协同设计(Multi-Scale Co-Design)
从后摩尔时代的发展方向来看,封测技术的发展必将为产业发展带来前所未有的机遇,产业链全方位协同创新将是推动我国集成电路封测业进一步发展的重要途径之一。在技术融合和经济需求的驱动下,芯片封装系统从独立走向协同设计。以往芯片生产流程从制造、封装到系统使各个环节形成了一种边界或鸿沟。
随着异构集成时代的到来,这种产业模式受到了冲击,协同设计与集成开发被寄以重望,协同设计与集成开发已成为先进SiP/Chiplet设计的主流趋势。传统的IC-封装-PCB依次的设计顺序已经不适用于今天的产品,IC-封装-PCB之间的综合协同设计已成为必然。
多物理场协同设计(Multi-Physics Co-Design)
随着异构集成功能模块日前复杂,一个封装系统可能要同时面临光、电、热、应力等多物理场耦合挑战,业内越来越多的需要多物理场协同设计应对这些挑战。
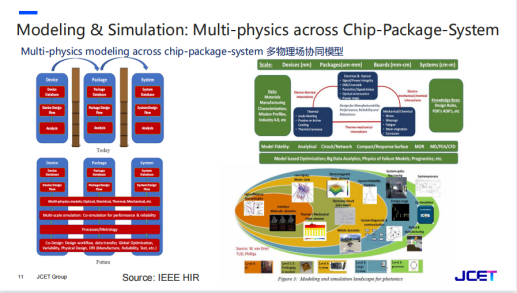
在单颗芯片和封装系统日趋复杂趋势下,为了确保半导体封装满足性能要求,长电科技的设计和特性分析团队在芯片的开发过程中,通过协同设计与前后端客户紧密合作,推动协同设计。封装的“联合设计”营造了良好的开发环境,为实现最佳性能提供助力,也可在微系统集成服务商业模式上提供更多可能。
总结
芯片-封装-系统协同设计驱动了多尺寸和多场协同设计和分析,在这种趋势下,协同设计及优化对于市场上有竞争力的产品变得越来越重要。系统级封装、先进封装和以小芯片为代表的新技术需要系统技术协同来获得最优解。协同设计优化给设计自动化及仿真工具、新技术的整合也带来了挑战。
长电科技在自身经营日益稳健向好的同时,也更加注重推动半导体封装测试领域的整体发展。今年提出从“封测”到“芯片成品制造”的概念升级,带动行业重新定义封装测试的产业链价值,长电科技将积极和业界合作推动芯片-封装-系统协同设计的发展。








评论
文明上网理性发言,请遵守新闻评论服务协议
登录参与评论
0/1000