台积电于2月19日在ISSCC 2024大会上介绍用于高性能计算(HPC)、人工智能芯片的全新封装平台,在已有3D封装、HBM基础上整合硅光子技术改善互联、节省功耗。
台积电业务开发资深副总裁张晓强(Kevin Zhang)在演讲中表示,开发这项技术是为了提高人工智能加速器的性能。要想增加更多的HBM高带宽存储芯片和chiplet小芯片,必须增加更多的组件和片上基板,这可能会导致互连和电源方面的问题。
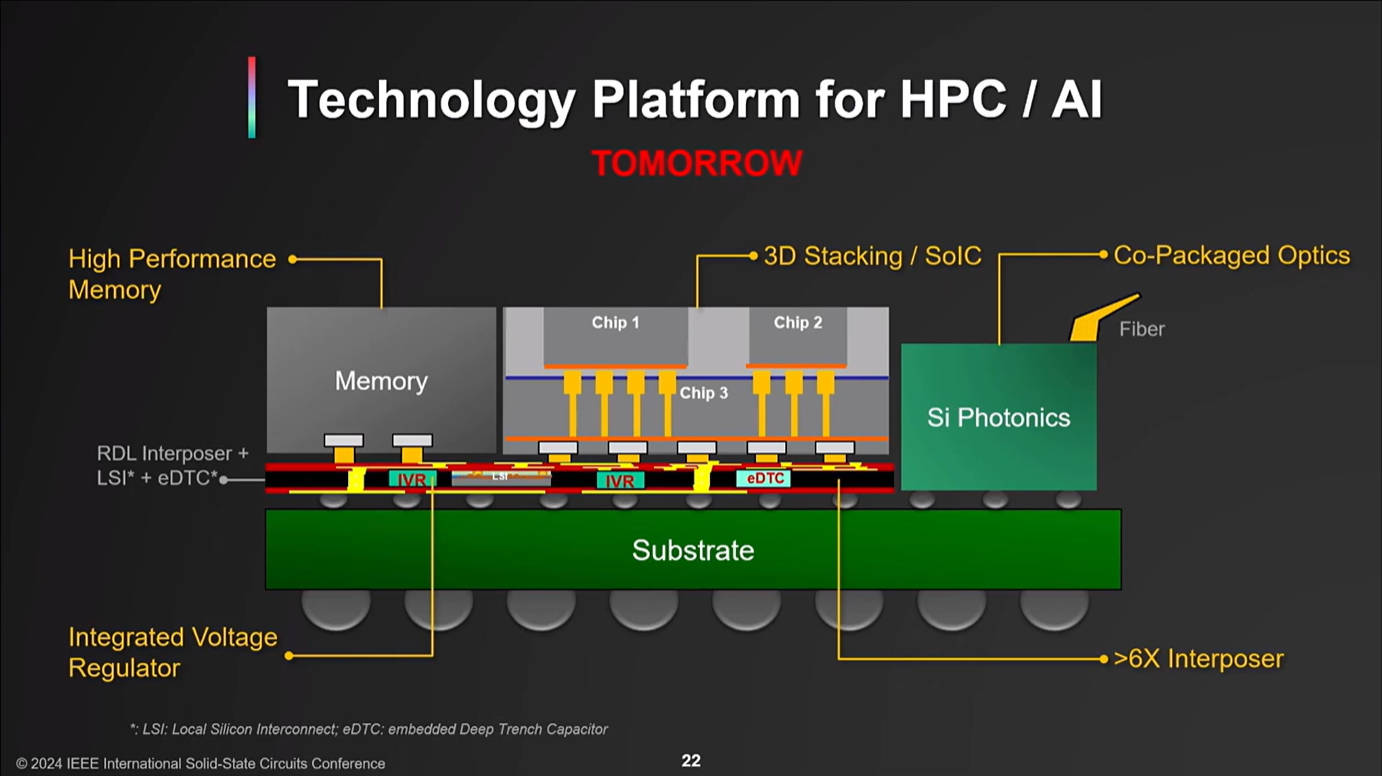
张晓强解释,台积电的新封装技术通过硅光子技术,使用光纤替代传统I/O电路传输数据;另一大特点是,使用异构芯片堆叠在基板上,采用混合粘合技术,以最大限度提高I/O性能。计算芯片和HBM芯片将安装在硅中间件上。他还表示,这一封装技术将采用集成稳压器来处理供电问题。
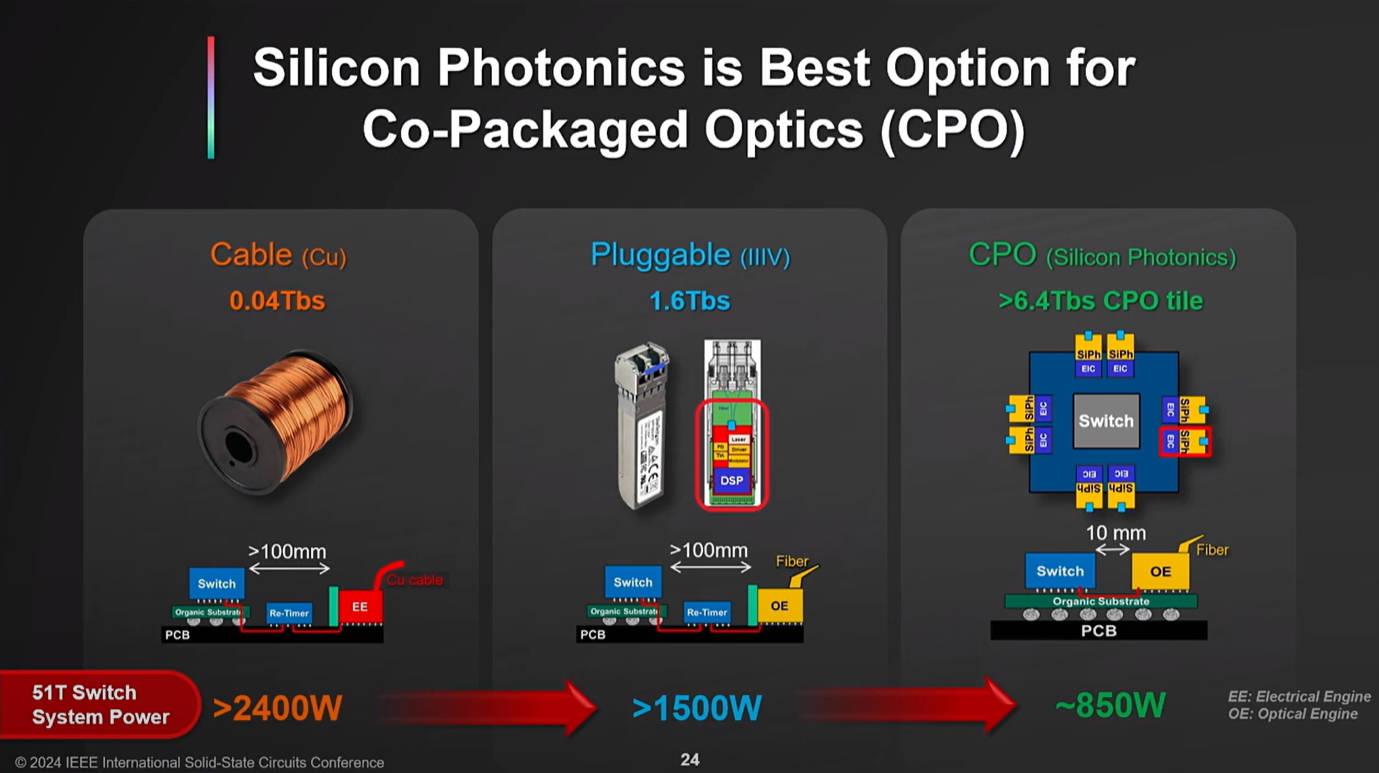

张晓强暂未透露这一全新封装技术的商业化时间。他表示,目前最先进的芯片可容纳多达1000亿个晶体管,但对于人工智能应用来说,3D封装技术可以扩展至单颗芯片包含1万亿个晶体管。
(校对/赵月)








评论
文明上网理性发言,请遵守新闻评论服务协议
登录参与评论
0/1000