1、集微大会演讲嘉宾【11-20】:全球智囊团首批阵容介绍
2、AI终端加速轻量化升级,晶存科技新一代 ePOP5存储方案应势而来
3、AI成第四增长极:芯联集成2025年技术变现提速,2026年利润转正在即
4、台积电公布最新路线图:A12、A13、N2U工艺技术发布,2029年之前不使用High-NA EUV
5、国安部披露:某芯片公司工程师泄露商业机密,遭法律严惩
6、不只iPhone!苹果准备推出六大新产品
7、库克透露苹果CEO任期“首个大错误” 最自豪的时刻是它
1、集微大会演讲嘉宾【11-20】:全球智囊团首批阵容介绍
九载深耕,从厦门启航到上海绽放,集微大会已成为中国集成电路领域规格高、规模大、影响力广的行业风向标,更是全球半导体人每年必赴的产业盛会。
十年筑芯,再启新程。5月27-29日,第十届集微大会将在上海张江盛大举办。十周年重磅升级,规模与规格创历届之最,预计演讲嘉宾将超过150位,超 7000 位行业精英齐聚参会。大会由半导体投资联盟、ICT知识产权发展联盟主办,爱集微承办,全新 “2+2+2+4+N+1” 架构,聚合全球顶级资源,共筑半导体高质量发展新生态。
大会嘉宾阵容陆续揭晓,继首批全球智囊之后,第二批10位行业专家重磅登场,持续聚焦技术前沿与产业变局,助力穿透周期、直击核心:
①哥本哈根商学院副教授Douglas B. Fuller《探讨特朗普第二任期半导体产业跨国政策的变动》结合其对中国科技政策及全球产业格局的长期观察,深入分析特朗普第二任期内美国及跨国半导体政策的调整走向,助力企业精准应对政策挑战。
②Flagship International总裁Andy Tuan《半导体材料供应链发展趋势》深入剖析当前全球半导体材料供需格局的演变逻辑,解读关键材料领域的技术突破与国产替代进程,研判在地缘变局与产业链区域化趋势下材料环节的供应链韧性与协同发展方向。
③知识力资深顾问张勤煜博士《硅光子发展趋势:技术演进与制造机会》系统拆解硅光子技术在后摩尔时代的演进路径,重点剖析硅光子制造环节中的结构性机会,助力企业在AI驱动的技术浪潮中精准识别并抢占战略先机。
④Bundy Group分析与咨询总监Alex Chausovsky《地缘政治对企业未来的影响》,结合其在宏观经济与工业领域的深厚积累,深度拆解地缘政治如何重塑企业未来的竞争格局,探讨企业如何针对政策变动与供应链风险制定行之有效的战略。
⑤DECISION Études & Conseil高级顾问Léo Saint-Martin《半导体价值链与去全球化》,将从欧洲视角出发系统拆解全球半导体价值链演进的核心逻辑,剖析去全球化趋势如何重塑产业分工格局与利益分配机制,前瞻性探讨半导体产业未来价值链重构的可能路径。
⑥East West Futures Consulting总监John Lee《欧洲芯片生态系统的下一阶段展望》,将系统剖析欧洲在提升芯片自主权、强化供应链韧性等方面的战略演进,为布局欧洲市场与应对政策变动提供极具实务价值的参考依据。
⑦TechoVedas创始人Kumar Priyadarshi《重构全球供应链:未来十年印度与中国大陆及台湾地区的战略协作》,深度拆解未来十年间印度如何与中国大陆及台湾地区在半导体领域展开复杂的战略协作,为开拓印度等新兴市场提供前瞻性战略指引。
⑧Focalpoint Consultants董事总经理RD Pai《决胜印度电子市场:系统制造转型下海外供应商的战略之道》,将深度解析印度电子市场的结构性机会,探讨在系统制造转型背景下海外供应商应如何调整战略以适应本土化需求,为开拓印度市场提供极具参考价值的战略指引。
⑨Counterpoint Research副总监Kevin Li(李健宇)《中国车规芯片的本土化发展》,将拆解中国车规芯片本土化的核心路径,剖析当前市场竞争格局,对未来3-5年行业发展趋势进行前瞻性展望,为本土芯片企业及车企提供战略参考。
⑩Prismark Partners资深顾问Terry Wang《人工智能驱动的超级循环——全球PCB与IC基板市场》,将深度剖析关键技术迭代路径,研判全球供应链重构趋势,为企业投资布局与供应链策略提供权威参考依据
不止于听,更在于“链接”
本届大会不止于专业内容分享,更注重高效链接与深度交流。分析师论坛首创专家深度互动环节,每日议程结束后均设置一小时以上的Q&A问答,让与会者能与国际大咖直接对话,打破单向传播,精准破解企业发展难题。
同时,大会配套 4000 平方米专业半导体展区,端侧AI算力+存储专区、先进封装产业链专区、半导体材料与工艺设备专区、IC设计/IP/EDA工具四大特色专区全面覆盖设计、制造、封测、材料设备全产业链,打造一站式资源对接平台;更有 4 场重磅闭门会议,精准聚焦并购整合、产教融合、资本赋能等核心领域,实现高端资源高效对接。
日前,大会早鸟票限时火热发售中,超值福利不容错过:单日票450元(原价600元),双日套票仅需800元(原价1000元),立省200元,优惠截止至 5月9日。所有与会嘉宾均获赠爱集微VIP会员季卡,两日全程参与更可获赠半年卡作为专属福利。
十年磨一剑,诚邀您共赴这场属于半导体人的年度盛会!

2、AI终端加速轻量化升级,晶存科技新一代 ePOP5存储方案应势而来
随着AI能力持续向端侧延伸,智能手表、AI眼镜、智能手环、AR/VR设备等新一代智能终端正加速向轻量化、高集成、低功耗、高性能方向演进。尤其在可穿戴设备领域,产品形态不断微型化,功能持续叠加,终端厂商对核心器件提出了更高要求:不仅需要更强的数据处理与运行支撑能力,也需要在有限空间内实现更优的结构设计与续航表现。
在这一趋势下,存储方案已不再只是基础配置,而是影响终端性能释放、主板空间利用、整机功耗控制以及工业设计落地的重要环节。
面向AI可穿戴与微型化智能终端不断升级的应用需求,晶存科技新一代 ePOP5 存储方案以更高集成度、更低功耗表现及更轻薄封装设计,为新一代智能终端提供更具适配性的存储支撑。

高集成设计,助力终端释放更多结构空间
面对智能手表、AI眼镜等空间高度受限的产品形态,终端内部器件不仅要性能更强,也要占用更少、设计更灵活。晶存科技新一代 ePOP5 采用 eMMC 5.1 + LPDDR5/5X 高集成设计,通过堆叠封装技术将存储与内存整合于更紧凑的空间中,有助于优化PCB布局、节省板级面积,并为整机结构设计释放更多空间。
在AI眼镜、智能手表等终端中,随着摄像头、传感器、连接模组及电源管理单元等器件持续叠加,板级空间愈发紧张,高集成存储方案的价值也进一步凸显。该方案能够有效减少分立器件占板面积,帮助终端厂商在有限主板空间内实现更紧凑的器件布局,为电池、传感器及其他关键模组预留更多设计余量,提升整机综合设计效率。

LPDDR5/5X加持,为AI终端带来更高效运行支撑
随着终端侧AI应用不断丰富,设备在本地处理、快速响应、多任务并行及传感器数据调用等方面,对存储性能的要求持续提升。晶存科技新一代 ePOP5 存储方案搭载 LPDDR5/5X 内存,速率可达 8533Mbps,并支持 eMMC 5.1 HS400 模式,可为终端系统运行提供更高效的数据读写支持。
随着语音交互、运动识别、健康监测、视觉辅助等AI功能在终端侧持续落地,高性能、高集成的存储组合正成为智能终端实现流畅体验的重要支撑。
在容量配置方面,晶存科技 ePOP5 可提供 2+64GB、3+64GB、4+64GB 等多种组合方式,可灵活满足不同终端平台在产品定位、系统需求与成本控制上的差异化配置需求。

更低功耗、更轻薄封装,兼顾续航与工业设计
对于智能穿戴类产品而言,续航始终是核心体验指标之一。晶存科技新一代 ePOP5 存储方案围绕低功耗需求进行优化,可更好适配智能穿戴设备长时间运行、全天候使用及多任务后台协同等应用特征,帮助整机在有限功耗预算内实现更好的性能平衡。
在封装设计方面,晶存科技 ePOP5 采用 8.0×9.5mm 封装规格,封装厚度为 Min 0.45mm、Max 0.57mm,可更好满足智能手表、AI眼镜等设备对紧凑空间与轻薄结构的设计要求,为终端产品在工业设计、模组布局及造型定义方面提供更大灵活度。
稳定可靠,助力客户加快产品导入节奏
面向消费级智能终端市场,存储产品不仅需要具备性能优势,也需要兼顾可靠性与可量产能力。依托自研主控设计与方案整合能力,晶存科技新一代 ePOP5 在性能调校、兼容适配及稳定性控制等方面具备更强支撑。
产品符合 JEDEC 标准和 RoHS 要求,工作温度范围覆盖 -25℃~+85℃,可更好满足智能穿戴设备在多样化日常环境中的稳定运行需求。
该方案可广泛应用于高端智能手表、智能手环、AI眼镜、VR/AR头显等终端设备,并可进一步覆盖更多对高集成、低功耗、小尺寸设计有明确需求的智能硬件场景。

持续完善高集成存储布局,赋能新一代智能终端创新
此次新一代 ePOP5 存储方案的推出,是晶存科技在高集成、小尺寸、低功耗存储产品方向上的进一步拓展,也体现了公司围绕AI终端演进趋势持续完善产品布局的方向。
未来,晶存科技将继续聚焦智能终端与新兴应用市场,围绕客户需求推进产品迭代与技术升级,以更具竞争力的存储解决方案,助力AI终端不断向更轻薄、更智能、更高效方向演进。
3、AI成第四增长极:芯联集成2025年技术变现提速,2026年利润转正在即
4月20日晚间,中国领先的一站式系统代工方案的领导者芯联集成发布了2025年度业绩报告及2026年第一季度业绩报告。在半导体行业周期波动与AI技术革命交织的2025年,芯联集成交出了一份“含金量”颇高的成绩单:营收逼近82亿元,亏损大幅收窄近40%,且毛利率实现了连续爬坡。2026年第一季度,公司借力行业景气上行,减亏幅度进一步扩大,盈利拐点临近。
这不仅是财务数字的改善,更标志着芯联集成从过去几年的高投入期,正式迈入了“技术变现”的收获前夜。随着AI业务成为第四大增长极,这家公司正在从国内领先的特色工艺晶圆代工厂,蜕变为AI基础设施的“能源底座”新玩家。
业绩拐点与行业卡位——从规模扩张到高质增长
根据财报披露,2025年芯联集成实现营业总收入81.8亿元,同比增长25.67%。尽管归母净利润仍录得-5.95亿元,但同比大幅减亏38.17%;扣非净利润为-11.19亿元,同比减亏20.63%。基本每股收益为-0.08元,同比减亏42.86%。
进入2026年,芯联集成的增长势头进一步加快。受益于销售规模扩大以及产品盈利能力提升,2026年第一季度实现营业收入19.62亿元,同比增长13.19%;归母净利润为-0.88亿元,同比大幅收窄51.53%。

盈利能力方面,公司2025年销售毛利率提升至5.51%,同比增加4.48个百分点。公司解释称,毛利率的改善得益于研发创新带来的产品迭代、精细化运营带来的生产效率提升,以及收入规模增长所显现的规模效益,这些因素共同有效摊薄了单位产品所分担的固定成本。公司董事长赵奇在业绩会上表示,2025年公司折旧压力已进入下行通道,预计2026年将进一步下降。
特别值得关注的是,2026年第一季度毛利率提升至5.69%,公司已连续7个季度实现正向毛利率,盈利拐点预期增强。2026年初以来,半导体行业景气度持续升温,公司8英寸产线稼动率维持较高水平。与此同时,高毛利的车规级SiC、功率模组产品占比持续提升,共同推动了毛利率的改善和亏损的大幅收窄。

在行业地位方面,芯联集成完成了从“跟随者”到“领跑者”的跨越。根据NE时代统计,2025年公司在国内乘用车功率模块装机量排行榜位列第四,车规产品已应用于中国90%以上的新能源车企。在碳化硅领域,根据Yole Group报告,2025年芯联集成SiC业务实现同比快速增长,成功跻身全球前五,占据约5%的全球市场份额;在MEMS领域,根据Yole发布的《MEMS产业现状2025》,公司位列全球MEMS晶圆代工厂第五名,是中国大陆唯一进入全球前五的MEMS代工企业。

图片来源:《Power SiC/GaN Compound Semiconductor Market Monitor Q1 2026》- Yole Group
新引擎爆发——AI业务构建增长曲线
芯联集成2025年及2026年第一季度业绩大增背后,既有新能源汽车、工控等成熟产品线的贡献,也受益于AI、光电等新业务的驱动。
在汽车电子方面,公司已构建起从主驱功率芯片到车身、热管理等全系统覆盖的完整产品矩阵,为整车厂提供了高可靠性的“一站式”芯片解决方案,2025年车载领域收入占比达45.43%。单车芯片价值量提升也将驱动公司业绩增长,公司预计,单车配套价值量将从2024年的约2000元持续提升至2027年的3500元,2029年有望达到4500元以上。在工业控制方面,公司产品广泛应用于光伏、储能、智能电网等领域,超高压IGBT产品已实现量产并挂网运行,为风光储充等新型电力系统提供了关键的底层支撑。
如果说车规与工控业务是公司稳健前行的“压舱石”,那么AI业务则是驱动未来高速增长的“新引擎”。正是基于这一深厚的功率与模拟芯片技术根基,公司敏锐地捕捉到“算力尽头是电力”的产业共识,2025年正式将AI列为第四大核心市场,聚焦AI服务器电源领域,稳步拓展业务边界。
针对AI算力“高能耗”的痛点,芯联集成没有局限于单一器件的供应,而是构建了覆盖“功率器件+隔离驱动+MCU+磁器件”的一站式代工方案,这一方案能够覆盖服务器电源50%以上的BOM成本,显著增强了客户黏性。技术层面,公司的55nm BCD工艺平台和碳化硅G2.0技术成功导入AI服务器电源客户。
数据显示,2025年公司AI相关业务收入占比已达8.02%,公司预计该比例将在2026年突破10%,成为公司增长的核心驱动力。同时,公司与超聚变(豫信电科旗下)设立联合实验室,深度绑定AI服务器硬件设计与芯片制造,进一步夯实了在该赛道的竞争优势。
在光电与具身智能领域,芯联集成的布局正从“点”状突破走向“面”状覆盖。公司与星宇股份、九峰山实验室合作,布局MicroLED智能光科技研发与制造项目,涵盖车载照明、AR-HUD及光通信领域,开拓了新的应用空间。在具身智能赛道,公司的芯片产品已导入超过10家人形机器人及非人形机器人客户,涵盖了语音交互(高性能麦克风)、环境感知(激光雷达芯片)和运动控制(驱动芯片)等核心环节,相关订单规模已达千万元级,成功卡位未来产业入口。
工艺平台进化与研发投入——夯实技术护城河
业务的快速拓展离不开底层技术的坚实支撑,芯联集成在持续开疆拓土的同时,持续加码核心工艺平台的研发创新,构筑起难以复制的技术壁垒。
2025年,芯联集成从单一晶圆代工向“一站式系统代工”的战略升维获得进一步深化落地,核心工艺平台实现三重大突破。
首先是碳化硅(SiC)领域的代际领先。公司第四代SiC MOSFET芯片开发完成,并将于第二季度量产,更关键的是国内首条8英寸碳化硅产线实现量产出货。相比行业主流的6英寸产线,8英寸产线能大幅降低芯片成本并提升产能,是芯联集成在成本与性能上领先于竞争对手的核心资产。基于此产线,公司650V—3300V全电压平台产品覆盖汽车主驱与AI数据中心电源两大高增长赛道,实现了从跟随到领跑的跨越。
其次是车规级高压BCD确立了技术制高点。公司拥有从0.18um到55nm的完整工艺平台,第二代90nm BCD平台已开发完成,55nm MCU平台开发完成,40nm MCU平台预计于2026年下半年进入量产阶段,能够完美适配汽车电子从分布式向域控制演进的需求。特别是针对48V系统和800V高压平台推出的BCD120V及SOI BCD 200V工艺,精准解决了SiC器件驱动的痛点。
第三是MEMS与GaN的全面布局。在MEMS市场,公司继续保持国内规模最大、技术最先进的代工厂地位,第三代麦克风进入量产,第四代通过初步验证;车载和消费类多轴运动传感器实现规模量产;激光雷达VCSEL芯片实现规模量产。同时,在GaN(氮化镓)领域,公司已加大研发力度,8英寸GaN功率器件芯片研发量产线已于2025年Q3通线,正在针对AI数据中心电源和新能源汽车进行送样验证与导入,进一步完善了第三代半导体的技术拼图。
上述突破的背后,高研发投入是重要支撑。2025年公司研发费用同比增长5.5%至19.43亿元,研发费用率保持在23.76%的高位;截至2025年末,公司累计申请专利1312项,累计获得专利574项,核心技术涵盖硅基功率、碳化硅、BCD工艺及MEMS传感器等领域,构建了严密的知识产权壁垒。

乘势行业上行周期,2026锁定百亿营收与盈利拐点
站在2026年的新起点上,芯联集成展现出了前所未有的信心。管理层明确表示,2026年将是公司实现“有厚度”盈利转正的关键之年,并吹响了营收超100亿元的冲锋号。
这一宏伟目标的底气,首先来自于AI业务的爆发式增长。随着GTC 2026引爆推理时代,AI服务器电源需求将持续井喷,预计2026年AI业务收入占比将超过10%,成为公司重要的增长极。其次,公司在汽车、工控、消费等领域的布局同步发力。第三,行业周期红利向公司倾斜,2026年硅基功率器件(MOSFET/IGBT)进入景气上行通道,特别是8英寸晶圆代工价格坚挺,将直接增厚公司的利润空间。
不仅如此,公司自身的产品结构优化也将提供持续动力,随着模拟IC、SiC及系统模组等高毛利业务占比的持续提升,叠加行业周期景气上行,从2026年Q1起,公司的业绩将发生质的飞跃,力争全年归母净利润转正,芯联集成正站在业绩腾飞的新起点。
4、台积电公布最新路线图:A12、A13、N2U工艺技术发布,2029年之前不使用High-NA EUV
台积电(TSMC)周三(4月22日)在其2026年北美技术研讨会上公布了截至2029年的通用制造技术路线图。此次发布的重点包括:1.2nm和1.3nm级制程(分别命名为A12和A13)、对N2家族的意外延伸N2U,以及在2029年前不计划采用High-NA EUV光刻技术。或许最值得关注的是,公司进一步明确了多路径并行推进新节点开发的策略。
“去年我们发布了A14,作为最先进的第二代纳米片(nanosheet)技术,计划于2028年投产,”台积电业务发展与全球销售高级副总裁兼副COO Kevin Zhang表示。
“今年我们推出了A14的衍生版本,包括A13和A12,均计划在2029年投产。A13是在A14基础上的渐进式优化,主要通过光学缩放实现,在保持完整设计规则和电气兼容性的同时,实现约6%的面积缩减,使客户仅需极少重新设计即可受益。”
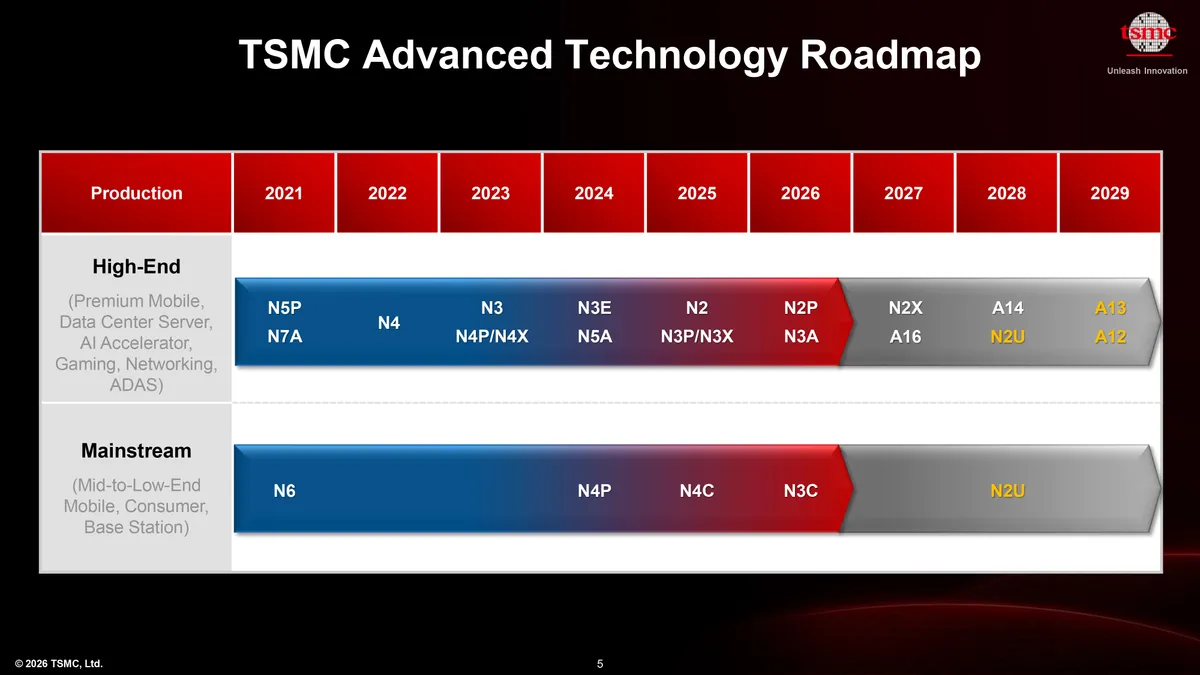
改变游戏规则
历史上,台积电的大部分收入来自智能手机行业,但近年来,AI和HPC(高性能计算)已反超手机业务。这一变化清晰体现在其路线图中:台积电将先进制程按终端市场需求进行“分轨”规划,而非“一刀切”。具体来说,公司将继续每年为客户端应用推出一个新节点,同时每两年为重负载的AI和HPC应用推出一个新节点。
一方面,N2、N2P、N2U、A14、A13等制程主要面向智能手机和客户端设备——这些市场更看重成本、能效和IP复用,对设计兼容性要求高,可以接受渐进式改进,只要能保持每年一个新节点的节奏。
另一方面,A16和A12等面向AI和HPC的节点,则必须提供显著性能提升以支撑技术迁移,成本相对不那么敏感。这类节点引入了Super Power Rail(SPR)背面供电技术,以解决AI数据中心和HPC负载的供电完整性和电流输送问题,并在性能、功耗和晶体管密度方面带来实质性提升,但更新节奏为两年一次。
A13与N2U:面向客户端的新节点
去年台积电推出了A14制程,基于第二代GAA纳米片晶体管,并通过NanoFlex Pro技术提供更高设计灵活性,预计将于2028年用于高端智能手机和客户端芯片。今年发布的A13则是在A14基础上的延续。
A13是A14的“光学缩版”,以最小扰动换取额外效率提升。其线性尺寸缩小约3%(约为原来的97%),带来约6%的晶体管密度提升,同时保持与A14完全一致的设计规则和电气兼容性。从某种意义上看,这延续了台积电以往通过光学缩放优化制程的传统(如N12、N6、N4、N3P),尽管此次提升幅度相对有限。这种方式使客户可以几乎无需重新设计即可复用IP,但性能提升也相对渐进。

A14本身可在功耗、性能和密度上实现全面提升,但需要全新的工具、IP和设计方法;相比之下,A13通过DTCO(设计-技术协同优化)实现增益,无需更改设计即可获得改进,预计于2029年量产。
此外,台积电还将推出N2U,为客户提供低成本升级路径。N2U是N2平台的第三年延伸版本,通过DTCO可实现:同功耗下性能提升约3%–4%,或同速度下降低功耗约8%–10%,并带来约2%–3%的逻辑密度提升。该节点与N2P IP兼容,使客户无需迁移到全新制程即可开发新产品,避免高昂成本。

例如,如果某公司在2027年基于N2P开发高端产品IP,那么可以在2028年利用N2U打造中端产品。
Zhang表示:“我们通过N2U持续扩展2nm平台,通过DTCO提升性能、功耗和密度。我们的策略是在节点推出后持续优化,让客户在获得渐进式PPA收益的同时,最大化设计投资回报。”
A16、A12与N2X:不惜成本追求极致性能
虽然N2将同时用于客户端和数据中心,台积电还在推进A16,该节点引入SPR背面供电,专为高性能数据中心应用打造。本质上,A16可视为带SPR的N2P,采用第一代GAA纳米片晶体管,在性能、功耗和密度方面优于N2/N2P,但成本更高。
值得注意的是,A16目前被列为2027年节点(相较此前2026年略有延后)。
Zhang解释称:“A16将在2026年具备量产准备,但实际产品放量取决于客户,我们预计在2027年进入规模生产,因此按该时间表对齐。”
同时,A16并不会取代N2X。N2X是N2P的高性能版本,采用传统正面供电,用于将频率推至极限。
A16之后,将由A12接棒(预计2029年推出),为数据中心级节点带来完整世代升级。虽然台积电未披露具体数据,但预计A12相对A16的提升,类似于A14相对N2的跃升——其将基于第二代GAA纳米片晶体管与NanoFlex Pro技术。
“ A16是我们首个采用SPR背面供电的技术,”Zhang表示,“A12将是下一代,在正面和背面同时持续缩放,以实现整体密度提升。”
High-NA EUV暂无计划
一个值得注意的点是,台积电2029年的A13和A12制程均不需要High-NA EUV光刻设备。这与英特尔的路线形成鲜明对比,后者计划从2027–2028年的14A节点开始采用High-NA EUV。
“我对我们的研发团队感到非常惊讶,”Zhang表示,“他们不断找到在不使用High-NA的情况下推进技术缩放的方法。未来某一天可能会用到,但目前我们仍能从现有EUV中获得收益,无需转向成本极高的High-NA。”
5、国安部披露:某芯片公司工程师泄露商业机密,遭法律严惩
据“国家安全部”微信公众号4月23日消息,资源的开发、技术的进步、数据的流动,无不深嵌于产业链供应链这张无形的网络中。产业链供应链安全事关国家经济安全和高质量发展全局。近年来,境外间谍情报机关针对我国产业链供应链的渗透、破坏与窃密行为日益隐蔽化、专业化、体系化,对我国经济安全、科技安全与数据安全构成严重威胁。
国家安全部指出,半导体技术的“内鬼泄密”。核心技术是产业链的“命门”,也是不法分子觊觎的重点目标。公开案例显示,国内某半导体企业前工程师张某,离职后违反保密义务,向境外组织非法提供核心生产工艺等商业秘密。核心技术的工艺参数、设计图纸外流,不仅会使企业数年研发投入付诸东流,还可能削弱我国在全球半导体产业链中的话语权。最终,张某受到了法律的严惩。
另外,国家安全部称,稀土是关乎高端制造、国防军工的战略资源,境外长期高度关注相关收储情况,千方百计获取我内部数据。公开案例显示,境外某有色金属公司通过其中方雇员叶某某,以金钱利诱国内某稀土公司副总经理成某。成某为谋私利违反规定,将其掌握的我国稀土收储品类、数量、价格等7项机密级国家秘密非法提供给境外。最终,叶某某、成某均受到法律的严惩。
国家安全部建议,严控芯片、服务器、工控设备等关键硬件准入,实施供应商安全审查与溯源管理;全面排查禁用存在安全风险的设备,建立供应商准入与动态管理机制,防范别有用心之人在硬件中植入窃密装置、预置间谍固件。
6、不只iPhone!苹果准备推出六大新产品
苹果( AAPL-US ) 正加速布局新一代产品版图。根据《彭博》记者葛曼(Mark Gurman) 最新说法,苹果目前同时开发多达六项全新产品类别,涵盖穿戴装置、智慧家庭与人工智能(AI) 应用,显示公司在既有iPhone、iPad 等产品更新之外,正积极寻求下一波成长动能。
报导指出,这六大新产品类别包括具备AI 功能的AirPods、智慧眼镜、AI 随身装置(Pendant)、智慧显示器、桌上型机器人以及安全摄影机。其中,多数产品属于苹果过去未涉足的全新领域,象征其产品线正进一步扩张。市场认为,这些装置将围绕苹果强化中的AI 技术发展,并高度依赖iPhone 作为运算与控制核心。
在产品时程方面,目前传出智能显示器可能最快于2026 年推出,安全摄影机亦有望于近期亮相;至于智能眼镜与桌上型机器人则仍处于较长期规划阶段,上市时间可能落在2027 年或之后。外界也关注,部分产品开发进度存在延后风险,显示苹果在新领域布局仍面临技术与市场挑战。
分析指出,苹果上一次跨入全新产品类别为2024 年推出的Vision Pro,但该产品至今市场反应有限,未能带动大规模需求。尽管如此,公司仍持续投入新产品开发,反映其不愿错过AI 浪潮与智慧装置整合带来的机会。
此外,随着苹果执行长库克预计于2026 年交棒由硬体主管特纳斯接任,外界也将这一系列新产品视为库克任内的重要布局之一。市场预期,未来苹果将以AI 为核心,整合穿戴装置与智慧家庭产品,打造更完整的生态系,以强化用户黏着度并拓展营收来源。
目前来看,苹果正从单一装置升级策略,转向多元产品与AI 应用并进的发展模式。未来新产品能否成功打开市场、带动新一波成长,将成为投资人关注焦点。(钜亨网)
7、库克透露苹果CEO任期“首个大错误” 最自豪的时刻是它
4月23日,据彭博社报道,苹果公司CEO蒂姆·库克(Tim Cook)计划在几个月后卸任。他表示,2012年在iPhone上推出苹果地图,是自己担任公司掌门人以来“第一个真正重大的错误”。

图1:库克
当时,这款地图应用在全球许多地方都无法正常使用,它向用户提供了错误的路线指引、错误标注地标,整体体验远不及当时iPhone上由谷歌提供的地图服务。
周二,库克在与刚被任命的继任者约翰·特努斯(John Ternus)共同出席一场内部全体会议上表示:“那个产品当时还没有准备好,我们却以为准备好了,因为我们测试的更多是本地相关内容。”

图2:苹果2012年推出的地图
这一产品的发布最终引发了库克任期内的第一次重大管理层调整,他解雇了软件部门负责人斯科特·福斯托尔(Scott Forstall)。福斯托尔是库克前任、苹果联合创始人史蒂夫·乔布斯(Steve Jobs)的亲密合作者。
库克还表示,有很多时刻让他感到自豪,但Apple Watch及其健康功能尤为突出。当Apple Watch在2014年首次亮相时,其主要的健康功能是心率监测。自那以后,苹果陆续增加了多种功能,比如高血压检测。
“我还记得所收到的第一位用户发来的Apple Watch反馈,他告诉我这款手表救了他的命。如今,当然我每天都会收到这样的信息,但第一次的触动尤其深刻,让我当时不禁停下了脚步。”(凤凰网)










