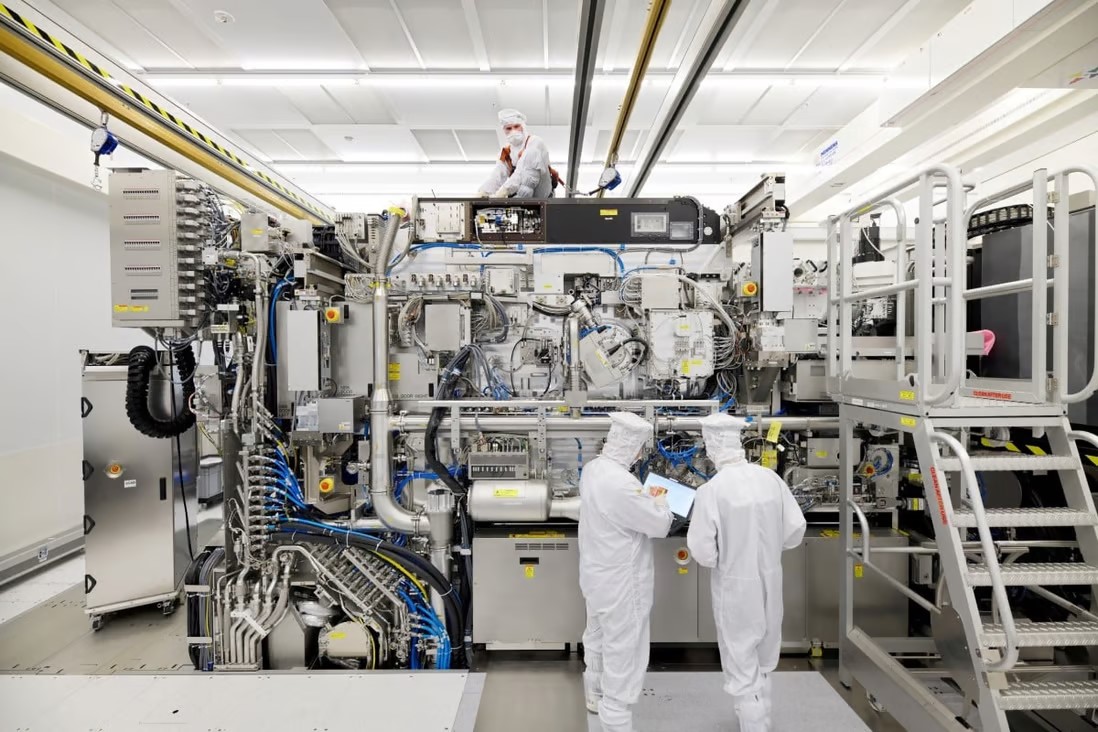
消息人士称,三星将于2024年第四季度至2025年第一季度开始安装其首台高数值孔径(High-NA)为0.55的EUV(极紫外)光刻机。该设备将主要用于研发目的,因为该公司正在开发需要High-NA EUV设备实现分辨率的下一代工艺技术。三星还与日本Lasertec、JSR、东京电子和新思科技合作开发High-NA生态系统。
据悉,ASML目前只生产了8台Twinscan EXE:5000,其中英特尔购买了第一台,并且订购了多台。因此,有人猜测三星可能已经获得ASML第8台Twinscan EXE:5000。
三星的第一台ASML Twinscan EXE:5000 High-NA光刻系统将安装在该公司的华城园区,在那里它将开发其用于逻辑和DRAM的下一代制造技术。值得注意的是,High-NA EUV设备的安装要求很复杂,因为它处理的是13.5nm波长的EUV光。因此,即使三星在2024年底前获得High-NA EUV设备,完成安装和校准也需要很长时间。它可能要到2025年上半年才能全面投入晶圆生产。
因此,三星的首款High-NA EUV光刻机将比英特尔晚一年左右投入使用,但仍将领先于竞争对手台积电和SK海力士。三星何时采用High-NA EUV进行量产还有待观察。
三星计划围绕High-NA EUV技术开发强大的生态系统。除了购买High-NA EUV光刻设备外,三星还与日本Lasertec合作开发专门用于High-NA光掩模的检测设备。据报道,三星据称已购买Lasertec的High-NA EUV掩模检测工具Actis A300。
“与传统的EUV专用工具相比,使用High-NA EUV专用工具检查半导体掩模可将对比度提高30%以上。”三星电子半导体研究所的Min Cheol-ki表示。
三星还与光刻胶制造商JSR和蚀刻机制造商东京电子合作,为2027年前实现High-NA EUV光刻系统的商业化应用做准备。三星还与新思科技合作,从传统的电路设计转向光掩模上的曲线图案。这一变化有望提高印在晶圆上的电路的精度,这对于进一步改进工艺技术至关重要。
ASML的Twinscan EXE High-NA EUV设备将实现8nm的分辨率,大大改善目前的Low-NA EUV系统(单次曝光最大达13nm)。这一进步将使晶体管缩小约1.7倍,密度几乎提高3倍。虽然Low-NA系统也可以达到这种分辨率和密度,但它们需要昂贵而复杂的双重图案化工艺。转向High-NA EUV技术有望消除对双重图案化的需求,简化生产,潜在地提高产量并降低成本。
实现这些8nm关键尺寸,对于使用3nm以下工艺技术生产芯片至关重要。然而,在2nm级节点,几乎所有芯片制造商都将使用双重图案化。英特尔还为Intel 20A(2nm)节点采用图案成型工具。英特尔只计划在Intel 14A(1.4nm)节点上使用High-NA EUV。
与此同时,向High-NA的飞跃也带来了一系列挑战。High-NA EUV设备更昂贵,售价达3.8亿~4亿美元,其成像范围减半,这将需要对芯片设计进行重大更改。此外,与Low-NA系统相比,High-NA EUV系统的尺寸更大,这意味着芯片制造商需要重新考虑其晶圆厂布局以适应这些新设备。
(校对/李梅)









