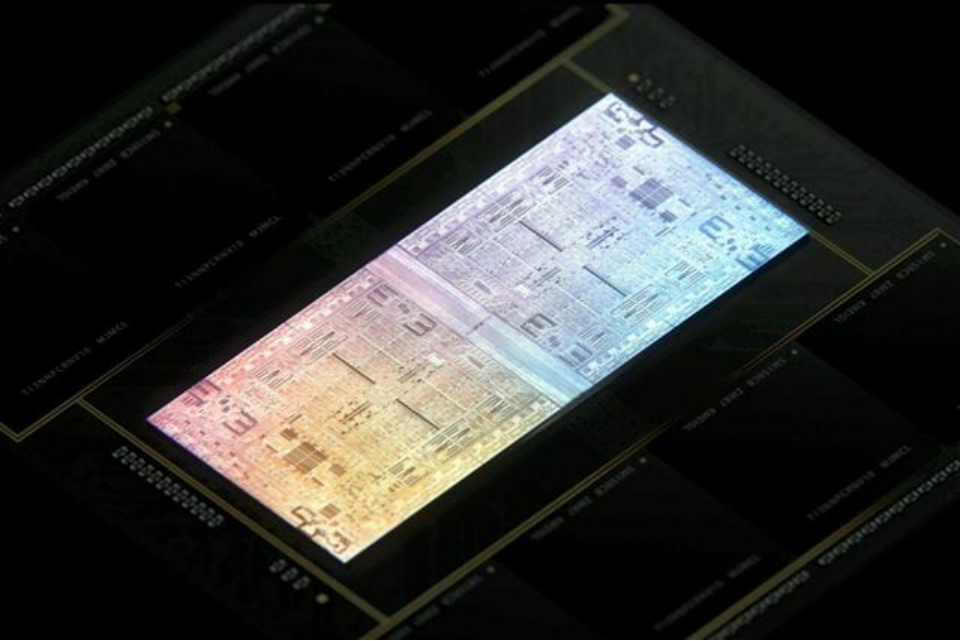
图源:电子时报
业内人士透露,苹果刚刚发布了其M1 Ultra SoC,该芯片采用内部开发的UltraFusion封装架构,将由台积电采用5nm工艺节点和先进封装技术制造,所需的ABF载板将完全由欣兴电子提供。
据《电子时报》报道,消息人士称,苹果创新的封装架构使用硅中介层连接两个M1 Max芯片,以创建片上系统(SoC),这是一种2.5D封装模式,可能适用于Mac Pro核心芯片。
消息人士称,为了改善风险管理,苹果将依靠台积电制造其最新的M1产品,采用的先进解决方案集成了5nm芯片技术和CoWoS-S(chip-on-wafer-on substrate with silicon interposer)封装工艺。
该人士指出,台积电在使用其CoWoS封装平台为网络IC和超大AI芯片等多种芯片解决方案供应商提供服务方面拥有丰富经验。台积电还一直在使用先进的工艺节点和InFO_PoP技术制造iPhone APs。
随着苹果继续推进其内部芯片设计,将越来越需要先进封装解决方案,而台积电将通过更多3D Fabric平台发挥越来越重要的作用。消息人士补充称,即使是芯片探测也将成为代工未来苹果硅产品的集成服务之一。
消息人士还指出,欣兴电子目前是M1系列ABF载板的唯一供应商,短期内M1 Ultra仍将如此,因为在日本Ibiden退出苹果供应链后,欣兴电子现在是唯一一家能够满足苹果制造技术和产能要求的IC载板制造商。
据报道,韩国LG Innotek将为苹果汽车应用提供ABF载板,奥地利的AT&S、中国台湾的景硕科技和臻鼎科技都可能有机会为M1 Ultra产品提供ABF载板。
消息人士称,M1 Ultra ABF载板的面积是M1 Max所需面积的两倍,这将有助于提高供应商的收入,但M1 Ultra powered Mac系列的目标是艺术家和创作者,最初的实际出货量不会很大。
为此,欣兴电子和其他同行将不得不加强技术升级,开发即将到来的3nm芯片生产所需的更先进的ABF载板,该人士补充说,这种载板将继续主导约70%的先进封装应用,尽管还有一种可能的趋势是,将会逐渐采用无载板的晶圆级封装。(校对/Aaron)









