1、晶圆边缘缺陷挑战日益严峻 先进封装如何应对?
2、中国存储模组涌现大批抛货潮 SSD价格下跌
3、传铠侠取消10月IPO计划
4、英特尔获五十亿美元投资意向 “何去何从”受关注
5、美印加强半导体合作,格芯在加尔各答建立研究中心
6、国科微亮相2024世界计算大会:4K/8K芯片算出精彩视界
1、晶圆边缘缺陷挑战日益严峻 先进封装如何应对?
更好的边缘缺陷测量能够提高良率,同时防止晶圆破损,但可能出现的缺陷数量正在增加。
随着开发领先芯片的复杂性不断增加,减少晶圆边缘、斜面和背面的缺陷变得至关重要。因为单一的缺陷可能会在多个工艺和多芯片封装中产生昂贵的连锁反应。
这种情况由于混合键合等工艺的广泛应用而更加复杂,混合键合需要完美的表面。同时,在多芯片/Chiplet(小芯片)设计中对可靠性的重视也在增加,在这种情况下,潜在的缺陷可能会导致多个Chiplet报废。找到缺陷的根本原因,确保它不是系统性问题,并且不会降低所有晶圆的良率,这一过程可能会导致数月的延迟。
在300mm晶圆边缘生产高良率芯片的难度极大,原因有很多,包括晶圆均匀性、工艺变化以及诸如薄膜应力等多层效应。保持晶圆整体的均匀性尤其具有挑战性。每片晶圆可能需要进行多达1000个工艺步骤,包括图案化、沉积、蚀刻、CMP(化学机械抛光)和电镀。虽然静电卡盘和晶圆边缘环专门设计用于提高工艺均匀性,但边缘条件仍然容易下降。干法和湿法工艺都可以使用,但湿法蚀刻也可能会损坏晶圆边缘——这是3D NAND工艺中的一个关键问题,3D NAND工艺正在迅速向混合键合推进。
最糟糕的情况是,边缘缺陷可能是晶圆破损的罪魁祸首,而这代价特别昂贵。布鲁克(Bruker)公司英国站点经理John Wall表示:“边缘缺陷可能是晶圆破损的主要原因,这会中断生产线,导致成本非常高。”这些成本与产品损失、清洁工艺室的时间有关,最关键的是找到破损的根本原因。
“晶圆破损通常发生在激进的工艺步骤期间,如快速热退火(RTA)或CMP。”Wall表示,“但导致破损的缺陷,作为破损的前兆,可以在之前的许多不同工艺步骤中形成。例如,通过处理影响晶圆边缘的错误。如果晶圆上不存在这些缺陷,那么晶圆在RTA或CMP过程中就不会破损。”
提高晶圆边缘芯片的良率可以带来显著的回报,具体取决于设备类型和良率。“晶圆边缘仍有很大的良率潜力,”DR Yield的CEO Dieter Rathei说道。根据工艺的不同,提升边缘良率的重点可能需要工艺、产品和良率工程师团队的资源,这可能成本高昂。“提升良率潜力很大,但从经济角度来看,问题是获得最后那一点良率提升的努力是否划算。”
晶圆边缘缺陷带来高昂成本风险
晶圆边缘的缺陷包括颗粒、碎裂、划痕、薄膜剥落等。在产品开发阶段,表面缺陷以及硅和外延层中的表体缺陷(如晶格空隙和滑移)必须及早发现,以便在大规模生产中及时解决。光学方法通常使用红外散射法检测隐藏的缺陷,如针孔或气泡。X射线衍射成像(XRDI)可以识别Si/SiGe超晶格结构中的外延层位错,这些位错会影响鳍式场效应晶体管(FinFET)和全环绕栅极(GAA)晶体管的性能。电子束计量使用电压对比可以帮助识别临界尺寸(CD)和套刻工艺变化,这些问题会因为薄膜应力和晶圆弯曲而加剧。
特别是3D NAND堆叠,需要确保在将多个内存堆叠与逻辑外围晶圆键合之前,内存堆叠是良好的。“制造中人们使用了双重光刻与双重蚀刻(光刻-蚀刻,光刻-蚀刻),但设备中一个芯片与另一个芯片之间的最终电气错位是光刻的函数——同时也受到蚀刻图案、薄膜均匀性和CMP均匀性的影响,” PDF Solutions的技术专家Tomasz Brozek说道。由于弯曲或蚀刻和CMP工艺不均匀性等问题,晶圆边缘区域可能存在最大的变异。
“通过使用面向检测设计的测试结构和具有电压对比功能的电子束探针,可以电学测量这些结构,可以对结构进行电气测量,以识别晶圆上排列(覆盖)和临界尺寸线宽的最小变化。”Brozek说,“由于你希望将良好的芯片叠加在良好的芯片上,因此在堆叠芯片之前需要了解它们的电学特性。而这已经在进行。”
在3D NAND制造中还有其他的变异问题,堆叠数百层薄膜也增加了损坏晶圆边缘的机会。特别是非常长时间的湿法蚀刻会在晶圆边缘产生残留物、提高粗糙度和损伤,导致材料剥落、漂移到其他区域并产生缺陷,从而导致半导体器件失效。
在采用先进封装的2.5D和3.5D配置中,堆叠芯片的过渡对控制晶圆边缘轮廓的CMP步骤提出了严格要求。在这里,边缘滚落必须在每片晶圆之间保持一致,因为边缘轮廓对键合质量尤为重要。
初始晶圆
晶圆制造商和芯片制造商使用无图案晶圆检测工具来确定所谓的裸硅、外延晶圆、SOI(绝缘体上硅)、硅上氮化镓(GaN)以及碳化硅(SiC)晶圆的质量。Onto Innovation的产品营销高级经理Burhan Ali表示:“不同基板类型的缺陷检测要求各不相同。例如,在硅晶圆中,用于领先节点的外延晶圆的检测要求具有更严格的工艺控制,最小缺陷尺寸要求已达到纳米级别。”
无图案晶圆检测通常使用基于光学图像或激光散射的方法,这些方法可以有效地捕捉晶圆正面和背面的表面缺陷,如颗粒、划痕和坑洞。符合或超过工艺规格的裸晶圆会被运送到晶圆厂,晶圆厂通常使用相同的检测方法进行进货质量检查。
无图案检测也在晶圆厂内部进行,用于监控工艺工具,检查生产线中的颗粒或其他污染物(所谓的“空白晶圆”)。此外,基板制造商还使用红外散射测量或X射线衍射成像等技术检查表体缺陷,以穿透晶圆表面,检测诸如针孔或气泡等缺陷。
检测晶圆的正面、背面和斜面
图案化晶圆检测平台用于检测晶圆的正面、背面和斜面上的缺陷(见图1)。Ali表示:“对裸晶圆和图案化晶圆的倒角检测通常使用明场和/或暗场照明,利用多个摄像头覆盖整个倒角区域,以确保晶圆的顶部倒角、顶点和底部倒角没有盲区。”“旋转晶圆以获取整个倒角的图像,然后对缺陷进行分类。”
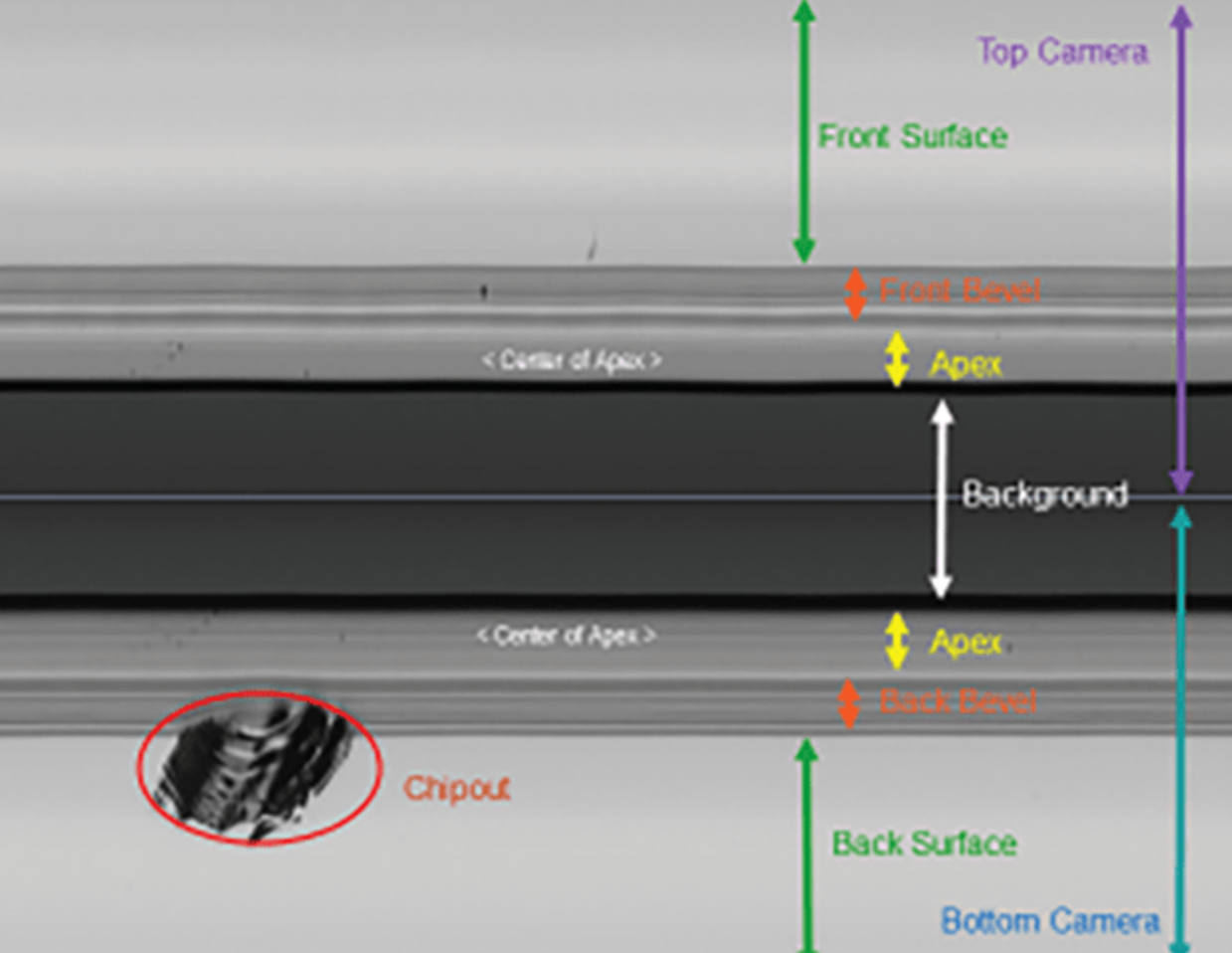
图1:晶圆边缘图像显示了倒角、顶点和体硅区域,以及背面缺陷。来源:Onto Innovation
在线光学检测通常用于检测工艺中的异常情况,并区分良品区域与缺陷区域。Ali表示:“一些较为流行的方法包括金模比较、模对模比较和基于CAD的检测。”
自动缺陷分类(ADC)通常采用机器学习算法来提高分类的准确性和速度。先进的ADC应用于所有表面,包括背面、正面和斜面——包括缺口。Ali说:“客户希望更快地得出结果,以优化他们的工艺并最大限度减少审核时间。”晶圆缺口用于在工艺工具中精确定位晶圆。但晶圆边缘的凹痕进一步揭示了硅晶格的晶体取向(111、100或110取向),设备工程师可以选择这些取向来优化设备的电气性能。
晶圆背面最常见的缺陷之一是热点。在深紫外线或极紫外线光刻过程中,背面颗粒可能会改变图案化时的焦深。此外,背面缺陷可能导致蚀刻和离子注入过程中工艺的不均匀性。在极端情况下,当晶圆片被静电卡盘拉平时,背面颗粒也会导致晶圆片破裂。
晶圆倒角处理也可能与颗粒问题有关。DR Yield的Rathei表示:“晶圆倒角有各种处理方式,甚至可能有来自背面的颗粒沿着边缘移动。”例如,倒角效果来自EBR(边缘去除剂),而且由于边缘的断裂会导致光刻图案缺陷,因此光刻覆盖和CD误差会更为显著。
当背面颗粒移动到正面设备时,无论是在处理、加工或在前开式晶圆传送盒(FOUP)中,它们可能会成为致命缺陷。边珠去除过程去除的是湿化学过程中形成的光刻胶或显影剂的边缘珠。光刻跟踪系统中的其他过程包括在晶圆过渡到下一个工艺步骤(通常是等离子体或反应离子蚀刻室)之前,对晶圆进行背面清洗和干燥。
在先进封装中,成品芯片的电性能变化变得尤为重要。在这种封装中,相同类型的Chiplet(如HBM4)会被配对并堆叠,异质Chiplet(如SRAM和处理器)也会堆叠,或者像HBM和处理器这样的异质芯片会进行横向互连。
由于许多晶圆边缘缺陷可能是由于工艺室中的晶圆中心定位误差造成的,因此每次都必须使用传感器来确保晶圆在其夹具上居中。Nordson Test & Measurement的WaferSense高级项目经理Vidya Vijay表示:“例如,Teach传感器可以帮助确定晶圆在蚀刻室中的放置是否居中。”她进一步指出,“精确的居中至关重要。任何偏离中心的位置都可能导致下游严重的良率问题。因此,它可以训练机器人和末端执行器将晶圆放置在中心。”
对于沉积工艺,使用电容传感器来确保沉积室中喷头和台座之间的间隙完全一致,每个300mm的工具通常有多个沉积室。Vijay表示:“这个间隙是一个非常关键的工艺标准,因为沉积厚度和均匀性的可重复性和再现性依赖于每片晶圆上保持一致的间隙。”
晶格缺陷
随着向3D结构的过渡,如FinFET、GAAFET和多层超晶格结构,外延层的质量监测变得至关重要。
Bruker的Wall表示:“对于微小缺陷,外延生长后的检测极为重要。”在外延层生长过程中(CVD工艺)形成的微小缺陷可能导致晶格不匹配、位错和滑移。这些是晶体缺陷,如果外延层生长失控,就会形成这些缺陷。
他还表示:“在材料中,特别是在硅/硅锗超晶格中,可能会出现应变的松弛或释放。”“XRDI技术对这些类型的缺陷非常敏感。我们通过晶圆中的晶面对准衍射平面。即使硅晶格中缺少一个原子,也会扭曲晶体晶格,产生一个强的应变场,这种应变场可能扩展到数十微米。如果你将其放大,滑移是指整个晶体平面移动并释放了张力。”
关键是捕捉超晶格结构中应变松弛的开始。Wall说:“XRDI对松弛的开始非常敏感,因此我们能够看到某些情况下位错的形成,并且具有良好的对比度。它提供了一种新的视角,使我们对松弛的开始更为敏感,因为在开始阶段,你的工艺本质上已经失控。”
先进封装的应对策略
混合键合需要严格的工艺控制——特别是在键合过程之前,因为任何存在于键合晶圆表面的颗粒都可能导致形成气孔。Onto Innovation的Ali表示:“随着铜(Cu)垫的关键尺寸和间距缩小,越来越小的颗粒可能会导致严重影响良率的气孔。”
在晶圆对晶圆键合的情况下,这是当前最常用的混合键合方法,需要更高灵敏度的光学检测工具来检测这些更小的缺陷。键合后还需要进行额外的检测步骤,以确保在介电-介电和Cu/Cu表面之间的键合区域没有气孔。
另一种在先进封装中使用越来越多的的光学技术是白光干涉仪(WLI),它是光学轮廓仪的一个子集设备。WLI具有非破坏性,视野宽广,达到2毫米,同时提供足够的横向和纵向分辨率来表征晶圆边缘滚落。
Bruker技术与应用开发总监Samuel Lesko表示:“滚落在晶圆的键合效果中扮演着重要角色。例如,这些晶圆通常经历了多个CMP步骤,因此跟踪晶圆的拓扑结构——它的下降速度和下降长度非常重要。光学轮廓仪在垂直方向上具有极高的纳米级灵敏度,这有助于在键合前作为质量控制在不同角度测量滚落。”
Lesko补充说,白光干涉仪和原子力显微镜(AFM)在表征CMP工艺中各有其作用,其中铜的抛光速度会比介电材料快,从而导致一些铜碟形。这个碟形腔必须在晶圆上非常均匀,以确保所有铜连接在退火时都能完成。
结论
为了最大化晶圆边缘的芯片良率,晶圆厂采用了多种计量和检测方法,并辅以机器学习算法以提供更快的结果。混合键合的应用对晶圆边缘性质提出了新的要求,必须满足这些要求才能实现高良率的晶圆对晶圆键合。(校对/孙乐)
参考
Ali,“裸晶圆片之谜:检测先进节点的背面、边缘和缺口缺陷”,2023年12月12日,https://semiengineering.com/a-bare-wafer-mystery-inspecting-for-back-edge-and-notch-defects-in-advanced-nodes/
本文编译来源:https://semiengineering.com/defect-challenges-grow-at-the-wafer-edge/
作者:LAURA PETERS
2、中国存储模组涌现大批抛货潮 SSD价格下跌
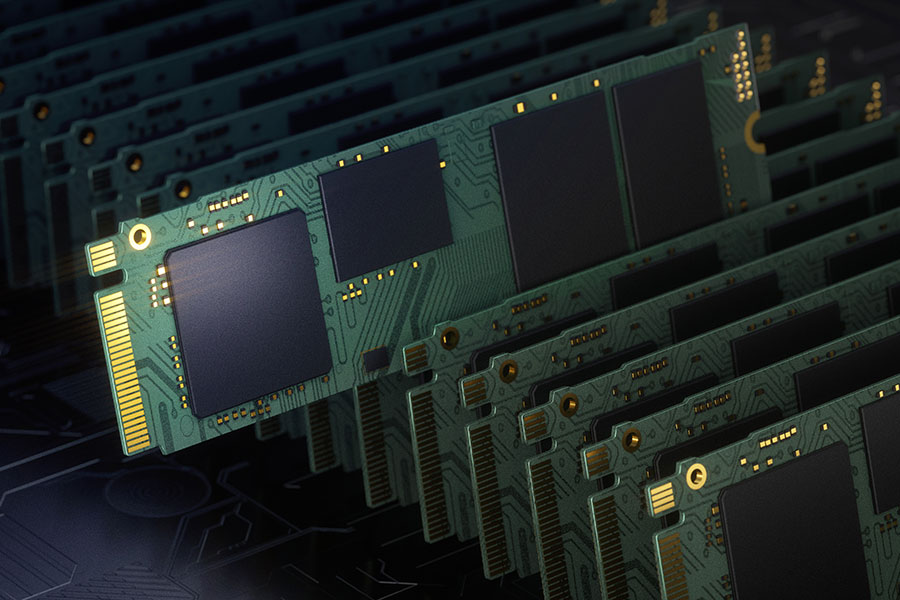
由于消费需求持续疲软及中国加大审核力度,中国存储模组制造商在2024年第二季度清理过剩库存后,正加速清理库存,近期涌现大批抛货潮,导致固态硬盘(SSD)市场的现货价格下跌。
尽管NAND晶圆价格高企,但现货市场的成品价格已回落至2023年初的水平。业内专家预计,中国市场的动荡将持续到年底,某些特殊产品可能会出现暂时短缺。
业内人士指出,近两年,中国积极推动国内供应链建设,不少本土存储模组厂商借此机会,拿下政府合约及本土品牌订单,业务快速增长,也带动一波渴望融资的新兴创业公司涌现。然而,许多存储供应商在2024年受到了税务审计,中国存储市场出现恐慌及焦虑的迹象。今年4月份,海关总署组织开展服务保障自由贸易试验区建设打击走私第一轮集中收网行动,主要针对虚开增值税发票、骗取补贴、骗取出口退税和洗钱等违法犯罪活动,打击利用自由贸易试验区和海关特殊监管区域便利政策走私,国内多家存储厂商牵扯其中,对整个行业的影响深远。
中国存储模块制造商抛售了大量低成本库存,为2024年第二季度预期的市场降温做准备。他们原本预计2024年下半年会出现复苏,但这并没有实现。9月份终端市场需求持续疲软等加剧了价格下行趋势,使该行业陷入困境,一些公司不得不抛售最后的储备。
除了中国市场需求疲软外,欧洲、东南亚、南美等海外市场也面临需求不及预期的局面。中国业内人士指出,虽然他们已经为淡季做好了准备,但没有预料到下滑幅度如此之大,业绩仅为2023年同期的一半左右。
根据市场研究公司Omdia的最新数据,第三季度销量最大的三层单元(TLC)256Gb NAND闪存产品的价格预计将从上一季度的1.54美元下降2.6%至1.5美元。这一趋势反映了更广泛的市场动态,即智能手机和PC等主要行业的需求尚未复苏,从而影响了价格的回升。
不过,市场并没有出现一致的下滑。Omdia预测,企业级固态硬盘(SSD)中使用的四层单元(QLC)NAND 256Gb价格预计将从第二季度的1.23美元上涨到第四季度的1.36美元。
NAND市场的这种两极分化,即面向消费者的产品价格下跌,而面向服务器的产品价格上涨,是一个值得注意的发展趋势。Omdia还将今年AI PC在PC市场的渗透率预测从11%下调至10%以下,称英特尔的重组冲击是原因之一。
3、传铠侠取消10月IPO计划

知情人士称,贝恩资本支持的存储芯片制造商铠侠(Kioxia)已取消了10月首次公开募股(IPO)的计划。
消息人士称,贝恩资本原本计划将铠侠的市值定为1.5万亿日元(103.9亿美元),但最近其上市同行的股票遭到抛售,使得这一定价变得具有挑战性。
美光科技和三星电子的股价较近期高点下跌约三分之一。
此前报道称,铠侠计划于10月底上市。铠侠曾表示,准备在适当的时候上市。
铠侠是全球第三大数据存储用NAND闪存制造商,2018年从日本企业集团东芝独立,2019年更名为铠侠。私募股权巨头贝恩资本和韩国SK海力士组建的特殊目的公司持有该公司56%的股份,东芝持有41%的股份。
据消息人士透露,贝恩资本和东芝均计划在铠侠上市后分阶段减持股份。
4、英特尔获五十亿美元投资意向 “何去何从”受关注
美国彭博社网站近日援引知情人士的话说,阿波罗全球管理公司已向英特尔公司提出数十亿美元的投资计划。这位知情人士表示,这家公司最近表示愿意对英特尔进行高达50亿美元的股权类投资;英特尔高管正在考虑阿波罗的提议。
彭博社称,在首席执行官帕特·格尔辛格的领导下,英特尔一直在制定一项成本高昂的计划,以重塑自身并引入新产品、新技术和外部客户。该计划导致一系列收益情况的恶化,削弱了投资者对英特尔的信心,并使其市值缩水了数百亿美元。
值得注意的是,虽然阿波罗如今以其保险、商业收购和信贷策略而闻名,但该公司在20世纪90年代起步时是一家专注于困境投资的公司。据介绍,目前英特尔和阿波罗已有商业往来。英特尔今年6月同意以110亿美元的价格向阿波罗出售其在爱尔兰一家合资工厂的部分股份,从而为其大规模扩张工厂网络带来更多外部资金。
阿波罗在芯片制造领域也有其他经验。去年,其同意牵头对西部数据公司进行9亿美元的投资,购买可转换优先股。
上述知情人士同时补充说,投资案的细节都尚未最终敲定,潜在投资规模可能会发生变化,谈判也存在失败的可能。
除这项尚不明朗的投资计划外,英特尔近期还传出更多资本动作。有消息称,高通近期已与英特尔接洽收购事宜,潜在交易将面临反垄断审查并需要剥离资产,此外,这项可能的交易也尚未提出正式报价。
路透社报道说,高通首席执行官克里斯蒂亚诺·阿蒙亲自参与了收购英特尔的谈判。此次收购将成为自2018年博通试图以1420亿美元收购高通以来科技行业最大的收购尝试。
博通此前的收购计划曾被时任美国总统特朗普以“国家安全风险”为由否决。与之类似的是,高通计划收购英特尔的尝试也将面临许多挑战。例如,该项交易可能会受到美国、中国和欧洲反垄断监管机构的审查。高通可能需要剥离英特尔的部分资产才能获得监管机构的批准。
此外,目前市场消息也无法明确拥有130亿美元现金、市值1880亿美元的高通将如何为收购估值1220亿美元(含债务)的英特尔筹集资金。同时,英特尔数十年来在其制造工艺上投资了数千亿美元,并为此聚集了数万名工程师。而高通从未经营过芯片工厂,市场也尚不清楚高通将如何处理收购英特尔代工业务的问题。
英特尔近期陷入发展困境,投资者质疑不断。作为曾经全球最大的芯片制造商,英特尔的经营状况多年来一直下滑,这一趋势在2024年进一步加速。今年8月份,公司公布了令投资者失望的收益报告,导致其股价创下50多年来的最大单日跌幅。投资者对该公司昂贵的芯片制造和设计计划表示怀疑,英特尔股价今年已跌去54%。
由于在近期生成式人工智能热潮中显著落后于竞争对手英伟达,英特尔一直试图通过专注于人工智能处理器并创建芯片合同制造业务(即代工厂)来扭转其业务。美国消费者新闻与商业频道网站称,近期格尔辛格在向员工发送的一份备忘录中重申了公司将大力投资代工业务的承诺,该项目未来五年可能耗资1000亿美元。
此外,格尔辛格和其他高管也在近期提出了一项削减业务和重组公司的计划,包括暂停在波兰和德国的工厂建设,并减少其房地产持有量。英特尔还表示,将为亚马逊的AWS生产定制网络芯片。(新华网)
5、美印加强半导体合作,格芯在加尔各答建立研究中心
在美国特拉华州举办四方领导人峰会之际,美国和印度加强了半导体合作,推出了一系列举措,包括建立半导体制造厂。
根据白宫9月21日发布的新闻稿,美国总统拜登和印度总理纳莫迪宣布了一项重要协议,即建立一家新的半导体制造厂,专注于先进的传感、通信和电力电子产品。这一举措旨在加强国家安全、下一代电信和绿色能源应用。
该工厂将生产红外线、氮化镓和碳化硅半导体,并得到印度半导体代表团以及Bharat Semi、3rdiTech公司和美国太空军的战略技术合作的支持。
在一份联合声明中,双方领导人赞扬了为建立弹性和安全的半导体供应链所做的努力,其中,印度建立的格芯加尔各答“全球能力中心”(Global Capability Centre)就是很好的例证。该中心旨在促进芯片制造的研发,推动零排放和低排放汽车、物联网设备、AI和数据中心的进步。他们指出,格芯计划与印度探索长期的制造合作关系,为两国创造高质量的就业机会。
双方领导人还欢迎美国国务院与印度半导体代表团建立新的战略合作伙伴关系,并与国际技术安全与创新(ITSI)基金保持一致。
声明肯定了为加强汽车市场供应链所做的努力,包括福特汽车公司利用其钦奈工厂进行出口的意向书。
此外,拜登和莫迪还概述了在未来五年调动超过9000万美元资金支持美印全球挑战研究所的计划,以促进两国大学和研究机构之间的高影响力研究伙伴关系。他们庆祝了旨在加强研究合作的新的美印先进材料研发论坛的启动。
双方领导人强调了在AI、量子技术和其他关键领域日益增长的合作,并强调了最近召开的美印量子协调机制会议,以及通过美印科技捐赠基金(IUSSTF)宣布为两国在AI和量子领域的研究提供新的奖励。值得注意的是,IBM已与印度政府签署了一份谅解备忘录,以推进AI创新和半导体研究。
最后,双方领导人对目前围绕5G部署和下一代电信加强合作的努力表示赞赏,包括美国国际开发署投资700万美元,与印度机构合作扩大亚洲Open RAN学院。
6、国科微亮相2024世界计算大会:4K/8K芯片算出精彩视界
9月24日,2024世界计算大会在长沙召开。本次大会以“智算万物·湘约未来—算出新质生产力”为主题,汇聚全球顶尖的计算产业专家、学者及企业家,共同探讨计算产业的最新动态、最新成果和发展趋势。国科微作为新质生产力的代表性企业,携4K/8K超高清芯片精彩亮相,展出系列4K/8K超高清视频解码芯片、显示芯片,以及自研神经网络处理器NPU技术。


本届大会由湖南省人民政府主办,湖南省工业和信息化厅、长沙市人民政府、中国电子信息产业发展研究院承办,设置了1场开幕式暨主题报告会,12场专题活动、1场创新大赛和1场成果展示,内容丰富多彩,精彩纷呈。
音视频技术在人们的日常生活工作中应用越来越广泛。在世界计算大会的展览区域,国科微“4K全面普及项目”展演吸引与会观众的关注,特别是项目的核“芯”4K超高清视频解码芯片GK6323V100系列备受瞩目。
国科微4K超高清视频解码芯片GK6323V100系列集成高性能多核CPU及GPU,性能优异;支持HDR VIVID、Audio VIVID,带来沉浸音效与臻彩视界;支持国产音视频标准,实现全国产交付;支持国密加解密算法,实现电视节目安全保障播出。GK6323V100系列芯片面向DVB/IPTVOTT/直播星市场打造,目前已在中国移动、中国电信、中国联通、中国广电四大运营商规模商用。


在近日湖南省工信厅发布的2024年湖南省音视频技术典型应用案例名单中,国科微“4K芯片及智能整体解决方案推动超高清智能终端全面普及”项目位列其中。该项目还入选了“国家超高清视频典型应用案例”。国科微正以实际行动推动4K超高清视频的全面普及应用,让更多家庭体验到超高清、超极致、超震撼的视听享受。
同时,国科微还展示了8K超高清视频解码芯片以及4K超高清显示芯片。其中,8K超高清视频解码芯片GK6525V100支持8KP120全通路处理,已应用于2022北京冬奥会和“百城千屏”项目。4K超高清显示芯片GK6780V100是业界首款支持TV及商显的标准OpenHarmony平台,基于GK6780V100鸿蒙平台,国科微携手下游客户推出了教育大屏、会议机、数字标牌等多种形态的终端产品。
视听电子是电子信息制造业的压舱石,是推动经济社会数字化转型的重要工具和实现人民群众美好生活的重要载体。《关于加快推进视听电子产业高质量发展的指导意见》指出,要持续推进技术创新、制度创新、软硬协同创新,加快构建现代化视听电子产业体系。
音视频高端芯片作为视听电子的核心元器件,是视听电子产业蓬勃发展的坚实基石。国科微将夯实在4K/8K超高清领域的技术优势,深度布局NPU,并不断拓展AI在超高清领域的应用场景,为实现我国现代化视听电子产业体系的构建注入核芯动力。









