从单片设计向Multi-Die设计的转变已成为行业发展的必然趋势,但这并非毫无挑战。传统的单片设计在接近其极限尺寸时,会面临良率降低和单片芯片成本上升等显著问题。Multi-Die集成技术通过将系统拆分为多个较小的芯片,有效地解决了规模扩展和成本控制的问题。
超大规模计算和高性能计算领域的领军企业已经认识到,小芯片(Chiplet)在Multi-Die环境中能够实现高效的协作设计,从而带来显著的成本效益和跨异构IP模块的灵活集成。然而,Chiplet生态系统目前尚未达到完全标准化,基于Chiplet的设计在封装、供电、验证、时序控制、版图规划、安全性、可测试性以及热管理等方面仍面临诸多挑战。
为了克服这些难题,新思科技与世芯科技(Alchip)—— 一家专注于高性能计算和人工智能ASIC的公司——携手合作,共同致力于实现Multi-Die设计的高投资回报率和物理性能优势。
Multi-Die设计的Chiplet灵活性
新思科技与世芯科技的合作,汇聚了双方数十年来在IP和EDA开发领域的丰富经验和专业知识。新思科技贡献了经验证的完整IP解决方案,包括112G和224G以太网、PCIe 6.0、PCIe 7.0以及UCIe等,同时还提供了业界领先的设计与验证EDA工具。世芯科技则以其针对高性能计算(HPC)优化的物理设计方法、大规模高速接口IP集成技术、以及2.5D先进封装设计能力,共同赋能双方的重要合作。
随着I/O和内存Chiplets需求的不断增长,这些小型集成电路(IC)与其他Chiplets结合,能够构建出更为庞大的片上系统(SoC)。这一趋势成为了推动双方合作的关键驱动力。在此过程中,需要将单片裸片所承载的功能进行划分,并有效地转移到更小的配套单元中去。
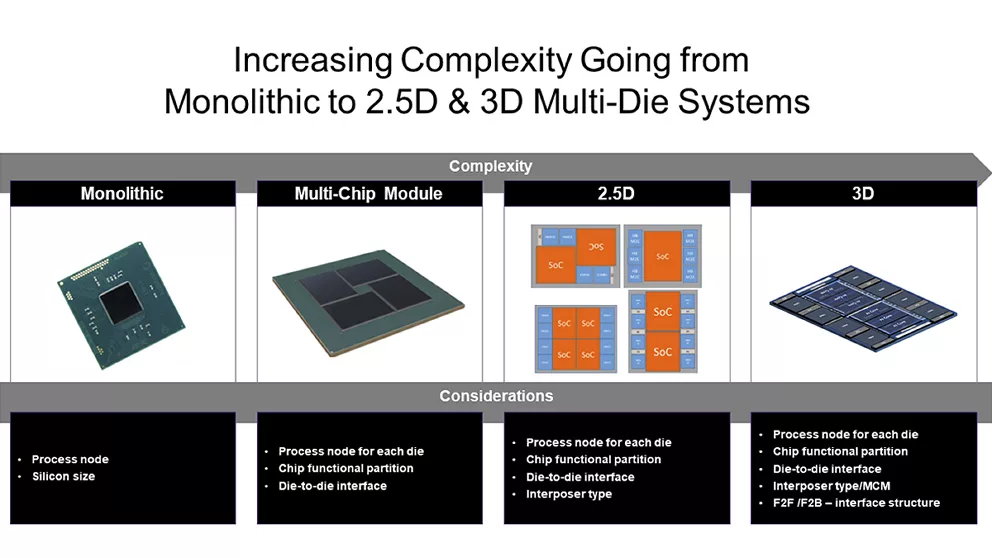
向先进制程节点的演进已成为不可逆转的趋势,在这一进程中,传统的单体SoC在效率和成本方面的优势逐渐减弱。随着制程技术的不断进步,将所有功能集成到单一裸片上的做法在先进节点上变得越来越难以应对和管理。因此,工艺优化成为了推动Multi-Die集成的主要动力,使得开发者能够针对系统功能的各个部分在不同的技术节点上进行优化。
Chiplet技术的引入带来了诸多好处,包括提供经验证的功能模块,提高生产效率和可预测性,并显著缩短产品上市时间。
什么是Soft Chiplet?
利用多个Chiplet能够带来显著的优势,包括提升性能、增加投资回报率、增强可重用性以及加速产品上市时间。实施Multi-Die设计还有助于灵活选择工艺节点、提升性能并降低高速接口的风险。
然而,这项技术也伴随着一些挑战,如封装复杂性增加、非经常性工程成本上升以及电源和延迟管理的复杂性提高。为应对这些问题,新思科技与世芯科技展开合作,推出了基于新思科技IP的可定制Soft Chiplet解决方案,旨在提升设计灵活性并优化架构设计。用户可以根据具体应用需求对这些Soft Chiplet进行“硬化”处理。
这一概念在多个应用场景中展现出巨大的潜力,尤其在高性能计算领域具有重要意义。随着人工智能技术的快速发展,对计算能力和服务器规模的需求不断增加,将功能从芯片中分离出来,可以在封装内部构建更大、更复杂的SoC。然而,这种方法并不能解决所有问题,因此Chiplet的灵活性显得尤为重要。
典型的Soft Chiplet开发者寻求的解决方案并不是一成不变的,而是希望根据特定需求进行优化,并需要支持广泛的设计空间以进行定制和调整。

在不同芯片间划分功能通常是一项复杂且具有挑战性的任务。然而,新思科技与世芯科技的合作提供了一种解决方案,该方案不仅大幅降低了设计复杂性,还通过成熟且灵活的产品显著提高了可控性,从而有效缩短了开发周期。
这种工艺允许Chiplet针对特定的工艺节点和封装进行专门优化,同时支持配置、芯片尺寸和深宽比的调整。通过拆分单片SoC方案,并结合两家公司在Multi-Die开发方面的丰富经验和深厚设计流程,该解决方案不仅加快了产品上市速度,还使用户能够专注于开发其核心专用集成电路(ASIC)。
随着Multi-Die设计的不断发展,单一芯片的容量已不再是技术瓶颈。当前,创建和集成Chiplet系统的简易性和速度成为了开发者面临的主要挑战。因此,一个用户友好且可定制的解决方案成为了相较于现成解决方案的独特且宝贵的优势。









